Fast Pixelated Detectors: ยุคใหม่สำหรับ STEM
JEOL NEWS ฉบับที่ 53 No.1
Peter D Nellist และ Gerardo T Martinez
ภาควิชาวัสดุศาสตร์ มหาวิทยาลัยอ๊อกซฟอร์ด
บทนำ
ในช่วงสองทศวรรษที่ผ่านมา กล้องจุลทรรศน์อิเล็กตรอนแบบส่องกราดแบบส่องกราด (STEM) ได้กลายเป็นเครื่องมือที่เหมาะสำหรับการถ่ายภาพด้วยความละเอียดของอะตอมและการศึกษาสเปกโตรสโกปีของวัสดุ โดยเฉพาะอย่างยิ่งเมื่อต้องการข้อมูลเชิงปริมาณ มีเหตุผลหลักสองประการสำหรับสิ่งนี้: (i) STEM ช่วยให้สามารถถ่ายภาพและสเปกโตรสโกปีพร้อมกันเพื่อเปิดเผยโครงสร้าง องค์ประกอบ และพันธะที่ความละเอียดของอะตอม (ii) โหมด STEM ภาพที่ใช้กันทั่วไปนั้นไม่ต่อเนื่องกันซึ่งนำไปสู่การตีความข้อมูลได้ง่ายขึ้น [1] โหมดภาพที่ใช้บ่อยที่สุดใช้ประโยชน์จากเครื่องตรวจจับวงแหวนด้านมืด (ADF) เพื่อตรวจจับความเข้มของการกระเจิงไปยังมุมที่ค่อนข้างสูง ภาพ ADF ที่ได้แสดงทั้งลักษณะที่ไม่ต่อเนื่องกันและความไวในการจัดองค์ประกอบ ดังนั้นจึงเป็นวิธีการที่มีประสิทธิภาพมากของวัสดุการถ่ายภาพ [2] ในการถ่ายภาพ ADF STEM ความเข้มรวมที่ตกกระทบบนตัวตรวจจับ ADF ทั้งหมดจะถูกรวมเข้าด้วยกันเพื่อให้ค่าสำหรับพิกเซลของภาพที่สอดคล้องกับตำแหน่งโพรบ ดังนั้นรายละเอียดหรือความผันแปรของความเข้มใดๆ ในระนาบเครื่องตรวจจับ STEM ภายในพื้นที่รวบรวมของเครื่องตรวจจับจึงสูญหายไป ในบทความนี้ เราจะสำรวจว่ารูปแบบความเข้มดังกล่าวสามารถนำมาใช้ใน STEM ได้อย่างไร โดยเฉพาะอย่างยิ่งผ่านการใช้ ptychography เพื่อให้การสร้างภาพเฟส
ก่อนที่เครื่องมือ STEM ความละเอียดสูงจะพร้อมใช้งานอย่างแพร่หลาย การถ่ายภาพด้วยความละเอียดของอะตอมได้ดำเนินการโดยใช้การถ่ายภาพแบบเฟสคอนทราสต์ใน TEM แบบธรรมดา (CTEM) ซึ่งเป็นเทคนิคที่เรียกว่า TEM ความละเอียดสูง (HRTEM) [3] ในภาพดังกล่าว การกระเจิงแบบไดนามิกของอิเล็กตรอนในตัวอย่างและการเปลี่ยนแปลงในพารามิเตอร์การถ่ายภาพที่แม่นยำอาจส่งผลกระทบอย่างมากต่อภาพ รวมถึงการพลิกกลับของคอนทราสต์ ซึ่งไม่ชัดเจนในทันทีว่าอะตอมหรือคอลัมน์อะตอมปรากฏเป็นคอนทราสต์ที่มืดหรือสว่าง (ดูสำหรับ ตัวอย่าง [4]) ในทางตรงกันข้าม ลักษณะที่ไม่ต่อเนื่องกันของ ADF STEM มักนำไปสู่จุดสูงสุดที่สว่างสำหรับอะตอมหรือคอลัมน์อะตอม
ตัวอย่าง เช่น กราฟีน ที่บางและมีองค์ประกอบแสง จะได้รับการถ่ายภาพอย่างมีประสิทธิภาพมากกว่าใน HRTEM มากเมื่อเทียบกับ ADF STEM เนื่องจากอิเล็กตรอนที่กระเจิงจากตัวอย่างดังกล่าวถือได้ว่าทำให้เกิดการเลื่อนเฟสเพียงเล็กน้อยในคลื่นอิเล็กตรอนที่ส่งผ่าน สามารถแสดงให้เห็นว่าวัตถุที่มีเฟสอ่อนแอสร้างสัญญาณน้อยมากใน ADF STEM [5] ในขณะที่ความคลาดเคลื่อน CTEM สามารถใช้เพื่อสร้างแผ่นเฟสเสมือนที่ช่วยให้การถ่ายภาพเฟสมีความเปรียบต่างต่ำ ความสำคัญของการถ่ายภาพเฟสคอนทราสต์ใน CTEM ได้รับการเน้นในด้านการถ่ายภาพทางชีววิทยาโดยรางวัลโนเบลสาขาเคมีประจำปี 2017 สำหรับการพัฒนา cryo-EM การถ่ายภาพที่ใช้สำหรับการวิเคราะห์อนุภาคเดี่ยวในการถ่ายภาพทางชีวภาพคือการสร้างภาพคอนทราสต์ของเฟส และแน่นอนว่านี่เป็นตัวขับเคลื่อนสำหรับการพัฒนาเพลตเฟสเพื่อเพิ่มคอนทราสต์เฟส [6]
โดยหลักการของการแลกเปลี่ยนซึ่งกันและกัน [7, 8] การกำหนดค่าของเครื่องตรวจจับ STEM มีบทบาทเช่นเดียวกับการกำหนดค่าการส่องสว่างใน CTEM ดังแสดงในรูปที่ 1 เครื่องตรวจจับช่องแสงแนวแกน (BF) ขนาดเล็กใน STEM เทียบเท่ากับการส่องสว่างตามแนวแกนในแนวขนานในระดับสูงใน CTEM เครื่องตรวจจับ STEM ที่ใหญ่กว่านั้นเทียบเท่ากับลำแสงที่ไม่ต่อเนื่องที่บรรจบกันใน CTEM เครื่องตรวจจับ ADF ใน STEM ค่อนข้างคล้ายกับการส่องสว่างแบบกรวยกลวงใน CTEM สำหรับการถ่ายภาพด้วยเฟสคอนทราสต์ HRTEM ต้องใช้ลำแสงที่มีความสม่ำเสมอสูงและขนานกันสูง ซึ่งเทียบเท่ากับเครื่องตรวจจับ STEM ในแนวแกนขนาดเล็ก ตอนนี้ชัดเจนแล้วว่าทำไม CTEM ถึงมีประสิทธิภาพมากกว่า STEM สำหรับงาน HRTEM: ใน CTEM ลำแสงคู่ขนานจะส่องสว่างตัวอย่าง และการกระจายไปยังมุมบางมุมที่สอดคล้องกับรูรับแสงที่เป็นตัวเลขของเลนส์จะถูกรวบรวมและถ่ายภาพโดยส่วนใหญ่ ของอิเล็กตรอนที่กระจัดกระจายที่ถูกตรวจพบ ใน STEM ลำแสงที่บรรจบกันสูงจะให้แสงสว่างแก่ตัวอย่าง แต่จะรวบรวมเฉพาะอิเล็กตรอนที่ส่งไปยังเครื่องตรวจจับแนวแกนขนาดเล็กเท่านั้น ดังนั้นจึงตรวจพบอิเล็กตรอนที่ส่งผ่านเพียงส่วนน้อยเท่านั้น สำหรับวัสดุที่ไวต่อรังสีซึ่งประสิทธิภาพของกระบวนการสร้างภาพเป็นสิ่งสำคัญ การถ่ายภาพ BF STEM นั้นไม่เหมาะสม
ในบทความนี้ เราพิจารณาตัวตรวจจับพิกเซลแบบเร็ว (FPD) ที่บันทึกแผนที่ความเข้มสองมิติของระนาบตัวตรวจจับ STEM สำหรับตำแหน่งโพรบแต่ละตำแหน่งในการสแกนแบบสองมิติ ส่งผลให้ชุดข้อมูลสี่มิติ (4D) สามารถทำได้ ถือเป็นชุดข้อมูลการสร้างภาพ STEM สากล เราแสดงให้เห็นว่าชุดข้อมูล 4D ช่วยให้สามารถถ่ายภาพเฟสเชิงปริมาณได้ และเนื่องจากอิเล็กตรอนที่ส่งผ่านทั้งหมดถูกตรวจพบจึงมีประสิทธิภาพทางอิเล็กตรอนมาก ทำให้สามารถถ่ายภาพในขนาดที่ค่อนข้างต่ำได้
มะเดื่อ. 1

การเปรียบเทียบการกำหนดค่าการถ่ายภาพสำหรับภาพคอนทราสต์เฟสใน CTEM และ STEM ที่แสดงให้เห็นถึงหลักการของการตอบแทนซึ่งกันและกัน ใน CTEM ใช้ช่องรับแสงขนาดเล็กเพื่อให้แสงใกล้เคียงกับการส่องสว่างแบบคู่ขนาน มุมบรรจบกันของลำแสงมีขนาดเล็กกว่ามุมรับ (รูรับแสงตัวเลข) ของเลนส์ใกล้วัตถุมาก ดังนั้นจึงตรวจพบอิเล็กตรอนที่ไม่กระจัดกระจายและกระจัดกระจายทั้งหมด โดยการแลกเปลี่ยนซึ่งกันและกัน ความเท่าเทียมกันของ STEM คือเครื่องตรวจจับพื้นที่สว่างขนาดเล็กที่มีขนาดเล็กกว่าจานที่มีช่องแสงสว่างที่ไม่กระจัดกระจายในระนาบของเครื่องตรวจจับ อิเล็กตรอนที่ไม่กระจัดกระจายและกระจัดกระจายส่วนใหญ่จะไม่ถูกตรวจจับ ดังนั้นจึงไม่ใช่การใช้อิเล็กตรอนอย่างมีประสิทธิภาพ
รายละเอียดการทดลอง
เมื่อบันทึกชุดข้อมูล 4D STEM เวลาพักพิกเซลของโพรบในการสแกนจะถูกจำกัดด้วยความเร็วเฟรมของเครื่องตรวจจับ เวลาพัก STEM โดยทั่วไปจะน้อยกว่า 100 μs ดังนั้นจำเป็นต้องมีตัวตรวจจับที่มีอัตราเฟรมที่สูงมาก เครื่องตรวจจับควรมีความไวของอิเล็กตรอนเดี่ยวโดยมีประสิทธิภาพควอนตัมของเครื่องตรวจจับสูง งานที่นำเสนอนี้ทั้งหมดได้รับการบันทึกโดยใช้ระบบ JEOL 4DCanvas™ [9] ซึ่งติดตั้งอยู่บนระบบ STEM การปล่อยมลพิษในสนามเย็น JEOL JEM-ARM200F ที่ติดตั้งเครื่องแก้ไขความคลาดเคลื่อนของโพรบออปติก 4DCanvas™ เป็นเครื่องตรวจจับ STEM แบบหลายช่องสัญญาณที่มีความไวสูงพร้อมช่องสัญญาณขนาด 264 × 264 สามารถอ่านค่าได้ที่ความเร็ว 1,000 เฟรมต่อวินาที (fps) หรือเร็วกว่าเมื่อเทียบเป็นค่า binning (เช่น 4 ต่อ 1 binning ให้ 4,000 เฟรมต่อวินาที) เซ็นเซอร์ของเครื่องตรวจจับแบบพิกเซลนี้เป็นอุปกรณ์ตรวจจับอิเล็กตรอนแบบคู่โดยตรง ระบบ Oxford แสดงในรูปที่ 2
มะเดื่อ. 2
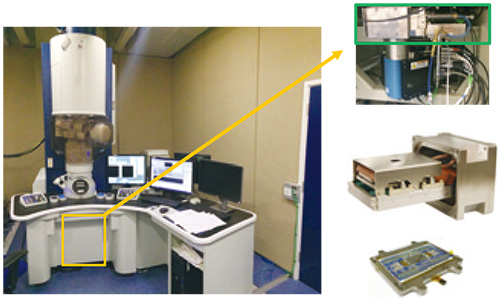
รูปถ่ายของเครื่องมือ JEOL JEM-ARM200F ที่ Department of Materials ใน Oxford พร้อมกับรูปถ่ายของระบบ JEOL 4DCanvas™ ที่ติดตั้งกับกล้องจุลทรรศน์
ผลสอบ
การสังเคราะห์ภาพ STEM แบบเดิม
เราเริ่มต้นด้วยการพิจารณาการถ่ายภาพของขอบของตัวอย่างของ Pt ที่เตรียมโดยการยกลำแสงไอออนที่โฟกัสออกแล้ววางแนวตามทิศทาง <110> ชุดข้อมูล 4D ถูกบันทึกที่ลำแสงพลังงาน 200 keV จากพื้นที่สแกนโพรบ 512 x 512 โดยเครื่องตรวจจับทำงานโดยไม่มีการ Binning ที่ 1,000 fps รูปที่ 3a แสดงกรอบภาพเครื่องตรวจจับเดียว การตรวจจับอิเล็กตรอนเดี่ยวมีความชัดเจนในภาพ การรวมตำแหน่งโพรบทั้งหมดเพื่อให้รูปแบบการเลี้ยวเบนอิเล็กตรอนของลำแสงคอนเวอร์เจนต์เฉลี่ยตำแหน่ง (PACBED) (รูปที่ 3b และ 3c) แสดงรูปแบบปกติของรูปแบบการเลี้ยวเบนอิเล็กตรอนของลำแสงคอนเวอร์เจนซ์
จากชุดข้อมูลนี้ สามารถสังเคราะห์ภาพจากอุปกรณ์ตรวจจับ STEM ต่างๆ ได้ ซึ่งทำได้โดยการรวมชุดข้อมูล 4D ไว้เหนือเรขาคณิตของตัวตรวจจับที่ต้องการในระนาบตัวตรวจจับของข้อมูล ส่งผลให้ได้ภาพ 2 มิติ รูปที่ 4 แสดงภาพจากรูปทรงเขตสว่างที่ไม่ต่อเนื่องกัน (IBF), ฟิลด์สว่างวงแหวน (ABF), ฟิลด์มืดวงแหวน (ADF) และฟิลด์มืดวงแหวนมุมต่ำ (LAADF) ที่มีขอบเขตการรวมที่แสดงโดยใช้ความเข้มของ PACBED . โดยเฉพาะอย่างยิ่ง จะเห็นได้ว่าภาพ LAADF แสดงคอนทราสต์ประเภท "รัศมี" อย่างไร สิ่งนี้สามารถอธิบายได้โดยการพิจารณาว่าความเข้มของ LAADF จะเพิ่มขึ้นสูงสุดเมื่อจาน BF อยู่ที่การเบี่ยงเบนสูงสุด ซึ่งจะเกิดขึ้นเมื่อโพรบเคลื่อนออกจากศูนย์กลางของคอลัมน์อะตอมเล็กน้อย และอิเล็กตรอนที่ส่องสว่างกำลังสัมผัสกับสนามไฟฟ้าสุทธิสูงสุด คล้ายกับเอฟเฟกต์ที่เห็นในการถ่ายภาพเฟสคอนทราสต์ [10] และคล้ายกับเอฟเฟกต์ที่เห็นในการถ่ายภาพช่วงเวลาแรก [11]
มะเดื่อ. 3

ข้อมูลที่บันทึกจากระบบ 4DCanvasTM ระหว่างการสแกนตำแหน่งโพรบ 512 x 512 เหนือตัวอย่าง Pt <110> โดยที่กล้องทำงานในโหมดฟูลเฟรมที่ 1,000 fps (a) กรอบเดียวที่จุดความเข้มของความสว่างแสดงถึงอิเล็กตรอนเดี่ยวที่ตรวจพบ (b) ผลรวมของรูปแบบการเลี้ยวเบนจากพื้นที่ที่สแกนทั้งหมดเพื่อสร้างรูปแบบค่าเฉลี่ยตำแหน่ง CBED (PACBED) (c) ลอการิทึมของความเข้มของรูปแบบ PACBED เพื่อให้มองเห็นเส้น Kikuchi เงาของเครื่องตรวจจับ JEOL ADF1 ยังมองเห็นได้
มะเดื่อ. 4

ภาพ STEM ที่สังเคราะห์ขึ้นจากข้อมูลที่บันทึกในรูปที่ 3 (a), (c), (e) และ (g) แสดงภาพสำหรับ IBF, ABF, ADF และ LAADF ตามลำดับ โดยมีขอบเขตการรวมเหนือตัวตรวจวัดดังแสดงใน (b )(d)(f)(h) ตามลำดับ
การสร้างภาพเฟสโดยการทำ ptychography
นอกเหนือจากตัวเลือกที่ยืดหยุ่นของหน้าลายของเครื่องตรวจจับภาพซึ่งสามารถเลือกได้ภายหลังการซื้อแล้ว ชุดข้อมูล 4D ยังสร้างโอกาสมากมายสำหรับโหมดการถ่ายภาพใหม่ที่เพิ่งเริ่มทำการสำรวจ โหมดใหม่อย่างหนึ่งคือการถ่ายภาพเฟสผ่านอิเล็กตรอน ptychography Ptychography ได้รับการเสนอโดย Hoppe [12] เป็นวิธีการแก้ปัญหาเฟสในการเลี้ยวเบนของอิเล็กตรอน และได้แสดงให้เห็นในการทดลองในช่วงต้นทศวรรษ 1990 ในบริบทของ STEM ที่มุ่งเน้นการสอบสวนโดย Rodenburg และเพื่อนร่วมงาน [13, 14] ในเวลานั้น ความสามารถทางเทคนิคของกล้องและการประมวลผลได้จำกัดเทคนิคนี้อย่างมาก และโดยทั่วไปแล้วภาพที่มีขนาด 32 x 32 พิกเซลเท่านั้นที่ทำได้ การพัฒนา FPDs ทำให้ ptychography กลายเป็นเทคนิคที่มีประสิทธิภาพและได้ผลใน STEM ระบบ 4DCanvasTM ที่ติดตั้งบน JEM-ARM200F STEM ที่ Oxford เป็นเครื่องมือที่ใช้ ptychography เป็นครั้งแรกในการแก้ปัญหาโครงสร้างที่ไม่รู้จักก่อนหน้านี้ของวัสดุที่สังเคราะห์ขึ้นเมื่อเร็ว ๆ นี้ [15]
ตามที่อธิบายไว้ใน [15] ptychography ใช้ประโยชน์จากแผ่นดิสก์ที่ทับซ้อนกันในรูปแบบการเลี้ยวเบนอิเล็กตรอนของลำแสงบรรจบกันที่เชื่อมโยงกัน ในการกำหนดค่า STEM ตัวอย่างจะส่องสว่างด้วยลำแสงที่บรรจบกันสูงซึ่งมุ่งเน้นเพื่อสร้างโพรบ สำหรับตัวอย่างที่เป็นผลึก ลำแสงที่เลี้ยวเบนจะสร้างแผ่นดิสก์ในระนาบเครื่องตรวจจับ STEM และในการทับซ้อนกันระหว่างแผ่นดิสก์เหล่านี้ จะเกิดการรบกวนที่สอดคล้องกัน ความเข้มที่ได้จะขึ้นอยู่กับเฟสของลำแสงที่เลี้ยวเบน ความคลาดเคลื่อนใดๆ ในออปติกที่สร้างโพรบ และตำแหน่งของโพรบ เมื่อสแกนโพรบ ความเข้มในบริเวณที่ทับซ้อนกันของแผ่นดิสก์จะลดทอนลง แท้จริงแล้ว fluctuation นี้คือที่มาของความเปรียบต่างของแลตทิซในภาพ STEM ใดๆ สมมติว่าความคลาดเคลื่อนได้รับการแก้ไขให้เป็นศูนย์ เฟสของความผันผวนนี้เทียบกับตำแหน่งโพรบคือความแตกต่างของเฟสระหว่างคานเลี้ยวเบนที่รบกวน จากข้อมูลนี้ ระยะของคานทั้งหมดสามารถกำหนดได้ เมื่อปัญหาเฟสได้รับการแก้ไขแล้ว ก็ไม่สมเหตุสมผลที่จะอธิบายวิธีการว่าเป็นการสร้างภาพหรือการเลี้ยวเบน เนื่องจากข้อมูลสามารถแปลงจากที่หนึ่งไปยังอีกที่หนึ่งได้อย่างง่ายดายผ่านการแปลงฟูริเยร์ Ptychography จึงเป็นการรวมกันของการเลี้ยวเบนและการถ่ายภาพ
ควรสังเกตว่าวิธี ptychography ที่นำมาใช้ที่นี่สำหรับ STEM แบบโฟกัสที่โพรบไม่ได้จำกัดอยู่แค่คริสตัลที่สมบูรณ์แบบ แต่เป็นเรื่องปกติสำหรับวัตถุใดๆ ตราบใดที่การส่งผ่านโดยตัวอย่างสามารถจำลองเป็นฟังก์ชันการส่งผ่านแบบทวีคูณได้ วิธีการทางคณิตศาสตร์ที่ใช้อธิบายรายละเอียดเพิ่มเติมใน [16] และแก้ไขสำหรับงานปัจจุบันตามที่อธิบายไว้ใน [15] แต่เพื่อความสมบูรณ์ เราจะอธิบายสั้นๆ ในที่นี้ ชุดข้อมูลที่วัดได้ 4 มิติแสดงไว้ |M(Kf, Ro)|2 โดยที่ตำแหน่งในระนาบเครื่องตรวจจับถูกกำหนดโดยเวกเตอร์พื้นที่ส่วนกลับ Kf และตำแหน่งโพรบส่องสว่างโดย Ro. การแปลงฟูริเยร์ของชุดข้อมูลเทียบกับ Ro ประสานงาน แต่ไม่ใช่ Kf พิกัดให้
ที่ไหน Qp เป็นคอนจูเกตตัวแปรความถี่เชิงพื้นที่ของภาพเป็น Ro, A(K) คือฟังก์ชันรูรับแสงสำหรับการส่องสว่างด้วยโมดูลัสที่ควบคุมโดยขนาดและตำแหน่งของรูรับแสงวัตถุประสงค์และเฟสที่สะท้อนความคลาดเคลื่อนใดๆ ที่มีอยู่ ψ(K) คือ การแปลงฟูริเยร์ของฟังก์ชันการส่งตัวอย่าง และ ⊗Kf หมายถึงการบิดตัวที่สัมพันธ์กับตัวแปรตำแหน่งระนาบเครื่องตรวจจับ ถ้า A(K) เป็นที่ทราบกันดีอยู่แล้วว่าผลิตภัณฑ์ทางด้านซ้ายของการบิดสามารถแยกส่วนได้และฟังก์ชันการส่งของตัวอย่างจะถูกกำหนดจากผลิตภัณฑ์ทางด้านขวา ดังนั้นแอมพลิจูดและเฟสของฟังก์ชันการส่งผ่านของตัวอย่างจะถูกกำหนด และสามารถพล็อตทั้งคู่ในเชิงปริมาณได้อย่างเต็มที่ จากการอภิปรายในบทนำ เป็นสิ่งสำคัญที่จะต้องทราบว่าระยะสามารถกำหนดได้ในเชิงปริมาณแม้ว่าจะไม่มีความคลาดเคลื่อนก็ตาม การสร้างภาพเฟสเชิงปริมาณอย่างมีประสิทธิภาพสามารถทำได้โดยไม่ต้องใช้แผ่นเฟสโดยใช้ STEM ptychography รูปที่ 5 แสดงการเปรียบเทียบรูปภาพจากตัวอย่างเดียวกันที่ถ่ายโดยใช้เครื่องมือ JEOL JEM-3000F ที่ทำงานเป็น HRTEM และภาพ ptychography จาก STEM แสดงว่าการสร้างภาพคล้าย HRTEM พร้อมใช้งานแล้วใน STEM
มะเดื่อ. 5
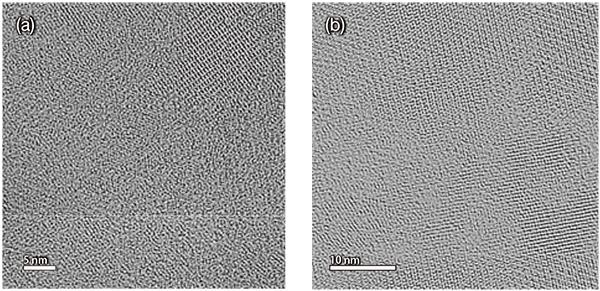
รูปภาพของฟิล์มบางของส่วนผสม C60/C70: (a) บันทึกในเครื่องมือ JEOL JEM-3000F ที่ทำงานในรูปแบบ CTEM ที่แรงดันไฟฟ้าเร่ง 300 kV; (b) บันทึกในเครื่องมือ JEOL JEM-ARM200F ที่ทำงานที่ 200 kV โดยใช้ตัวตรวจจับ 4DCanvas™ ตามด้วยการสร้าง ptychographic ใหม่ สังเกตความคล้ายคลึงกันในความคมชัดที่เปิดเผยโดยใช้การถ่ายภาพทั้งสองประเภท
เปิดใช้งานการถ่ายภาพในขนาดต่ำ
เนื่องจากอิเล็กตรอนที่ส่งผ่านทั้งหมดจะถูกตรวจจับเมื่อใช้ FPD เราอาจคาดว่าจะสร้างภาพที่มีสัญญาณรบกวนที่ต่ำกว่ามาก ซึ่งเป็นไปได้ด้วยเครื่องตรวจจับแบบไม่แบ่งส่วน และทำให้สามารถลดปริมาณอิเล็กตรอนลงได้ในขณะที่ยังคงรักษาสัญญาณรบกวนใน ภาพ. สมการ (1) ยังช่วยให้เราทราบได้อย่างชัดเจนว่าข้อมูลเกิดขึ้นที่ใดในระนาบเครื่องตรวจจับที่ข้อมูลเกิดขึ้นสำหรับแต่ละความถี่เชิงพื้นที่ในภาพ และด้วยเหตุนี้เพียงแค่ใช้พื้นที่เหล่านั้น สัญญาณรบกวน (ซึ่งกระจายไปทั่วระนาบเครื่องตรวจจับทั้งหมด) จึงค่อนข้างถูกปฏิเสธ . มันเหมือนกับการมีตัวตรวจจับ STEM ที่ปรับตัวเองให้เหมาะสมที่สุดสำหรับความถี่เชิงพื้นที่ที่แตกต่างกันในภาพ รูปที่ 6 แสดงการเปรียบเทียบภาพโดยใช้ ADF และ STEM ของ ptychographic ที่บันทึกพร้อมกันของโมโนเลเยอร์ของโบรอนไนไตรด์หกเหลี่ยม ในภาพ ptychographic สัญญาณรบกวนต่ำมาก และสามารถระบุตำแหน่งของที่ว่างโบรอนได้อย่างง่ายดาย
มะเดื่อ. 6
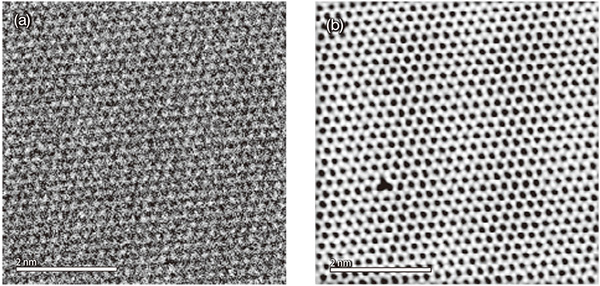
ภาพ ADF และภาพ ptychographic ของโบรอนไนไตรด์หกเหลี่ยมที่บันทึกพร้อมกันด้วยพลังงานลำแสงที่ 60 keV สามารถมองเห็นภาพ ptychography ได้ว่ามีสัญญาณรบกวนต่ำกว่ามาก และสามารถระบุข้อบกพร่องของตำแหน่งว่างโบรอนได้อย่างง่ายดาย
การแก้ไขความคลาดเคลื่อน
ก่อนที่จะมีการพัฒนาฮาร์ดแวร์เพื่อแก้ไขความคลาดเคลื่อนในกล้องจุลทรรศน์อิเล็กตรอน คาดว่า ptychography จะเสนอวิธีแก้ปัญหาความคลาดทรงกลม เมื่อทราบฟังก์ชันการส่งสัญญาณที่ซับซ้อน ผลกระทบของความคลาดเคลื่อนจะเปลี่ยนไป จุดมุ่งหมายสำหรับ ptychography นี้ประสบความสำเร็จโดยการพัฒนาตัวแก้ไขความคลาดเคลื่อน กระนั้น มันก็ยังคงเป็นกรณีที่บ่อยครั้ง บางทีอาจเป็นเพราะความคลาดเคลื่อนเล็กน้อยหรือการปรับแก้ตัวแก้ไขที่ไม่สมบูรณ์ ความคลาดเคลื่อนบางส่วนยังคงอยู่ วิธีการวนซ้ำที่พัฒนาขึ้นล่าสุดสำหรับ ptychography ไม่ได้ตั้งสมมติฐานเบื้องต้นเกี่ยวกับรูรับแสงซึ่งได้รับการแก้ไขแล้วในระหว่างกระบวนการวนซ้ำ [17] วิธีการโดยตรงที่ใช้สำหรับผลลัพธ์ในที่นี้ ต้องการทราบฟังก์ชันรูรับแสง แต่ก็แสดงให้เห็นด้วยว่าในกรณีของวัตถุที่มีเฟสอ่อนแอ สามารถวัดความคลาดเคลื่อนตกค้างได้โดยตรงจากฟังก์ชันที่ให้ไว้ในสมการที่ (1) และจากนั้นก็สามารถแยกส่วนได้ [15] รูปที่ 7 แสดงให้เห็นว่าแม้แต่เครื่องมือที่ไม่ตรงแนวอย่างมาก การแก้ไขความคลาดเคลื่อนที่นำเสนอโดย ptychography ก็สามารถกู้คืนภาพที่จำลองโครงสร้างของตัวอย่างได้อย่างถูกต้อง
ประโยชน์เพิ่มเติมที่เกิดจากความสามารถในการแก้ไขความคลาดเคลื่อนคือ การสร้างใหม่สามารถทำได้โดยสมมติว่ามีการพร่ามัวเฉพาะ แสดงให้เห็นแล้วว่าวิธีการนี้ทำให้เกิดเอฟเฟกต์การแบ่งส่วนแสงที่นำไปสู่การสร้างวัตถุสามมิติขึ้นใหม่ [15] ข้อมูล 3D ถูกจัดเก็บโดยเนื้อแท้ในชุดข้อมูล 4D ที่บันทึกจากกล้องจุลทรรศน์ แม้ว่าข้อมูลจะถูกบันทึกจากการสแกนครั้งเดียวที่จุดพร่ามัวคงที่
มะเดื่อ. 7

(a) ภาพของกราฟีนที่บันทึกที่ 80 kV โดยกล้องจุลทรรศน์ไม่ตรงแนวซึ่งนำไปสู่ความคลาดเคลื่อนขนาดใหญ่ (b) จากชุดข้อมูล ptychographic ความคลาดเคลื่อนได้รับการวัดและแก้ไขเพื่อให้มองเห็นตาข่ายได้ การแปลงฟูริเยร์ของรูปภาพแสดงให้เห็นว่าวงแหวนจุดที่สองมองเห็นได้ทั้งหมดแล้ว ต่างจากการแปลงฟูริเยร์ของรูปภาพ (a)
เอฟเฟกต์ไดนามิก
พื้นฐานทางทฤษฎีสำหรับ ptychography ที่อธิบายไว้ข้างต้นถือว่าการทำงานร่วมกันของลำอิเล็กตรอนกับตัวอย่างสามารถอธิบายได้ด้วยฟังก์ชันการส่งผ่านแบบทวีคูณ สำหรับตัวอย่างที่หนาและหนักกว่า จะใช้เงื่อนไขการกระเจิงของอิเล็กตรอนแบบไดนามิก และในกรณีนี้ ไม่สามารถทำการประมาณการคูณได้ ในการประมาณค่าแบบทวีคูณ จะถือว่าแอมพลิจูดหรือเฟสของลำแสงการเลี้ยวเบนไม่ขึ้นอยู่กับมุมของลำแสงที่เข้ามาเมื่อเทียบกับตัวอย่าง ในกรณีของการกระเจิงแบบไดนามิก มีการพึ่งพาอาศัยกัน
อย่างไรก็ตาม ไม่มีอะไรจะหยุดการบันทึกชุดข้อมูล 4D และเราสามารถใช้วิธีการสร้างภาพใหม่แบบเดียวกันกับข้อมูลได้ กลับไปที่ตัวอย่าง Pt wedge ที่ใช้ในข้อมูลสำหรับรูปที่ 4 ตอนนี้ เราสามารถดำเนินการสร้าง ptychographic reconstruction ดังแสดงในรูปที่ 8 พีคในภาพเฟสยังสามารถเห็นเพื่อแปลไปยังตำแหน่งคอลัมน์อะตอมและที่นั่น ไม่มีการกลับรายการคอนทราสต์ที่มองเห็นได้ ที่ความหนาบางส่วน ยอดเขาจะแสดงโครงสร้างคล้าย "รัศมี" Yang et al. ได้แสดงผลลัพธ์ที่คล้ายกัน [18]. แม้ว่าจะต้องมีการศึกษาอย่างละเอียดมากขึ้น แต่ดูเหมือนว่าภาพเฟสที่สร้างขึ้นใหม่โดย ptychographically นั้นแข็งแกร่งกว่าสำหรับเอฟเฟกต์ไดนามิกและการเปลี่ยนแปลงความหนามากกว่าภาพ HRTEM
มะเดื่อ. 8
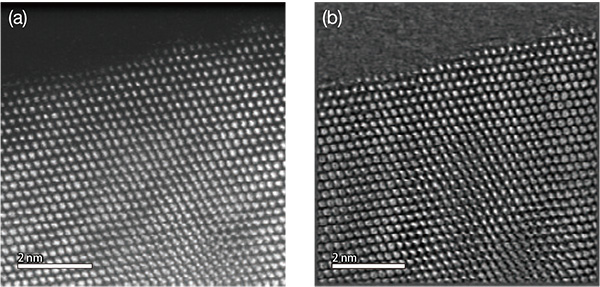
ภาพ ADF (a) และภาพเฟส ptychographic (b) จากตัวอย่างลิ่ม Pt ยังใช้ในรูปที่ 4 เมื่อความหนาเพิ่มขึ้น ภาพเฟสจะเริ่มสร้าง "รัศมี" เหมือนคอนทราสต์ แต่พีคยังคงอยู่ที่ ไม่เห็นตำแหน่งคอลัมน์อะตอมและการกลับรายการความคมชัด โปรดทราบว่ามีข้อผิดพลาดในการซ้อนแบบเอียงไปทางด้านล่างขวาของรูปภาพ ดังนั้นจึงมองเห็นคอลัมน์อะตอมเพิ่มเติมได้
สรุป
การพัฒนา FPD สำหรับ STEM ช่วยให้สามารถสร้างภาพที่มีความยืดหยุ่นสูงใน STEM และได้สร้างโอกาสสำหรับโหมดการสร้างภาพใหม่ ที่นี่ เราได้สำรวจการใช้งานของอิเล็กตรอน ptychography และแสดงให้เห็นว่าโพรบอิเล็กตรอน ptychography สามารถดำเนินการควบคู่ไปกับโหมด STEM ทั่วไปเช่น ADF ได้อย่างไร ภาพเฟสที่ได้มีความคล้ายคลึงกันมากกับ HRTEM แต่ก็พบว่ามีอัตราส่วนสัญญาณต่อสัญญาณรบกวนที่สูงมาก และทนทานต่อเอฟเฟกต์ไดนามิก Ptychography ยังช่วยให้แก้ไขความคลาดเคลื่อนซึ่งปรับปรุงความคมชัดของภาพให้ดียิ่งขึ้นและช่วยให้สามารถแบ่งส่วนแสงสำหรับการถ่ายภาพ 3 มิติได้
แม้ว่า STEM จะกลายเป็นเครื่องมือที่โดดเด่นสำหรับการศึกษาความละเอียดของอะตอม แต่ HRTEM ยังคงได้รับความนิยมสำหรับตัวอย่างที่เบาและบาง เช่น กราฟีนและวัสดุชั้นอื่นๆ และแน่นอนว่าเป็นโหมดหลักสำหรับ cryo-EM ของโครงสร้างทางชีววิทยา เนื่องจากขณะนี้ได้แสดงให้เห็นแล้วว่า ptychography ใน STEM สามารถให้ภาพเฟสที่มีสัญญาณรบกวนต่ำ ควบคู่ไปกับประโยชน์อื่นๆ ทั้งหมดของ STEM อาจเป็นไปได้ว่าเราอยู่ในจุดเปลี่ยนกระบวนทัศน์ที่ STEM ถูกมองว่าเป็นเครื่องมือสร้างภาพเฟสที่ทรงพลัง . การพัฒนา FPD สำหรับ STEM ทำให้มุมมองสามารถเปรียบเทียบได้กับ HRTEM และรูปที่ 9 แสดงภาพที่สแกนขนาด 1k x 1k
สุดท้ายนี้ เราสังเกตว่า ptychography เป็นเพียงโหมดใหม่หนึ่งโหมดที่ใช้ได้กับเครื่องตรวจจับ FPD ผู้เขียนคนอื่นๆ ได้สำรวจความเป็นไปได้ที่เกี่ยวข้องกับการวัดการพึ่งพาเชิงมุมของการกระเจิงในมุมที่สูงขึ้น วิธีการต่างๆ เช่น การส่งผ่าน การเลี้ยวเบนของ Kikuchi และการใช้มุมคอนเวอร์เจนซ์ที่ต่ำกว่า ความแรงของจุดเลี้ยวเบนที่มีอยู่ทั้งหมดสามารถวัดได้เป็นฟังก์ชันของตำแหน่งโพรบเพื่อให้ภาพคอนทราสต์การเลี้ยวเบนหลายภาพแบบคู่ขนานกัน ทำให้มีข้อมูลมากขึ้นสำหรับการกำหนดเวกเตอร์เบอร์เกอร์คลาดเคลื่อนผ่าน gb การวิเคราะห์ตัวอย่างเช่น
มะเดื่อ. 9
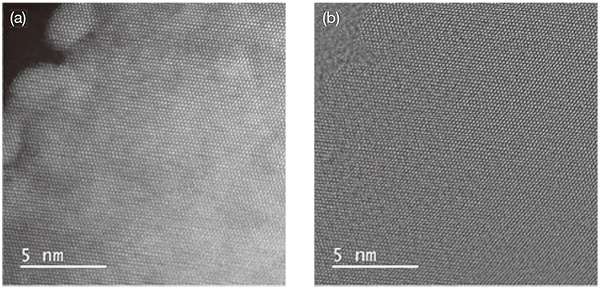
A ที่บันทึกพร้อมกัน (a) ADF และ (b) ภาพเฟส ptychographic จากตัวอย่างลิ่ม Pt <110> พร้อมการสุ่มตัวอย่างโพรบ 1 k x 1 k บันทึกด้วยความเร็วเฟรม FPD 4,000 เฟรมต่อวินาทีซึ่งแสดงให้เห็นว่ามุมมองขนาดใหญ่เป็นไปได้ใน STEM ที่เน้นการสอบสวน
กิตติกรรมประกาศ
เรารับทราบถึงความร่วมมือที่ประสบผลสำเร็จกับ Y Kondo และ R Sagawa, JEOL Tokyo, M Simson, M Huth, H Soltau, PNDetector GmbH และ L Strueder PNSensor GmbH ประเทศเยอรมนี เรายังรับทราบความช่วยเหลือทดลองจาก L Jones S Nam และ D Bradley (University of Oxford), Y Sasaki (Japan Fine Ceramics Centre), A Béché และ D Batuk (University of Antwerp) เป็นผู้จัดเตรียมตัวอย่าง ได้รับการสนับสนุนสำหรับโครงการนี้จาก EPSRC แล้ว (หมายเลขให้สิทธิ์ EP/M010708/1)
อ้างอิง
- PD Nellist, การสแกนด้วยกล้องจุลทรรศน์อิเล็กตรอนแบบส่องกราด, ใน: วิทยาศาสตร์จุลทรรศน์ PW Hawkes, JCH Spence (Eds.), Springer, 2007, pp. 65-132.
- PD Nellist, SJ Pennycook, หลักการและการตีความของการถ่ายภาพคอนทราสต์ Z-Contrast ของ Annular Dark-Field, ความก้าวหน้าในการถ่ายภาพและฟิสิกส์อิเล็กตรอน, 113 (2000) 148-203
- ดีเจ สมิธ, การบรรลุความละเอียดของอะตอมด้วยกล้องจุลทรรศน์อิเล็กตรอน, รายงานความก้าวหน้าทางฟิสิกส์, 60 (1997) 1513-1580
- RW Glaisher, AEC Spargo, DJ Smith, การวิเคราะห์อย่างเป็นระบบของการถ่ายภาพ HREM ของ Elemental Semiconductors, อัลตร้าไมโครสโคป, 27 (1989) 35-52
- TJ Pennycook, AR Lupini, H. Yang, MF Murfitt, L. Jones, PD Nellist, การถ่ายภาพเฟสคอนทราสต์ที่มีประสิทธิภาพใน STEM โดยใช้เครื่องตรวจจับแบบพิกเซล ส่วนที่ 1: การสาธิตการทดลองที่ความละเอียดของอะตอม อัลตร้าไมโครสโคป, 151 (2015) 160-167
- M. Marko, A. Leith, C. Hsieh, R. Danev, การติดตั้ง Retrofit ของการถ่ายภาพแผ่นเฟส Zernike สำหรับ cryo-TEM, วารสารชีววิทยาโครงสร้าง, 174 (2011) 400-412
- JM Cowley, ความคมชัดของภาพในกล้องจุลทรรศน์อิเล็กตรอนแบบส่องกราด, ประยุกต์ฟิสิกส์จดหมาย, 15 (1969) 58-59
- E. Zeitler, MGR Thomson, การสแกนด้วยกล้องจุลทรรศน์อิเล็กตรอนแบบส่องกราด, เลนส์, 31 (1970) 258-280 & 359-366.
- https://www.jeol.co.jp/en/news/detail/20170726.2143.html.
- N. Shibata, SD Findlay, Y. Kohno, H. Sawada, Y. Kondo, Y. Ikuhara, กล้องจุลทรรศน์คอนทราสต์เฟสดิฟเฟอเรนเชียลที่ความละเอียดอะตอม ฟิสิกส์ธรรมชาติ, 8 (2012) 611-615
- K. Müller, FF Krause, A. Béché, M. Schowalter, V. Galioit, S. Löffler, J. Verbeeck, J. Zweck, P. Schattschneider, A. Rosenauer, สนามไฟฟ้าปรมาณูเปิดเผยโดยวิธีการทางกลควอนตัมต่ออิเล็กตรอน การเลี้ยวเบนของแสง, การสื่อสารธรรมชาติ, 5 (2014) 5653
- ดับเบิลยู. ฮอปป์, เบกุง อิม อินโฮโมเจเนน พรีมาร์สตราห์ลเวลเลนเฟลด์. I. Prinzip einer Phasenmessung von Elektronenbeugungsinter ferenzen, แอ็กต้าคริสตัลโรกราฟี เอ 25 (1969) 495-501
- JM Rodenburg, BC McCallum, PD Nellist, การทดสอบเชิงทดลองเกี่ยวกับการสร้างภาพที่เชื่อมโยงกันที่มีความละเอียดสองเท่าผ่าน STEM, อัลตร้าไมโครสโคป, 48 (1993) 303-314
- PD Nellist, BC McCallum, JM Rodenburg, ความละเอียดที่เกิน 'ขีดจำกัดข้อมูล' ในกล้องจุลทรรศน์อิเล็กตรอนแบบส่องผ่าน, ธรรมชาติ, 374 (1995) 630-632
- H. Yang, RN Rutte, L. Jones, M. Simson, R. Sagawa, H. Ryll, M. Huth, TJ Pennycook, MLH Green, H. Soltau, Y. Kondo, BG Davis, PD Nellist, อะตอมพร้อมกัน- ความละเอียดของอิเล็กตรอน ptychography และการถ่ายภาพความคมชัด Z ขององค์ประกอบที่เบาและหนักในโครงสร้างนาโนที่ซับซ้อน การสื่อสารธรรมชาติ, 7 (2016) 12532
- JM Rodenburg, RHT Bates, ทฤษฎีกล้องจุลทรรศน์อิเล็กตรอนแบบความละเอียดสูงผ่าน Wigner-Distribution Deconvolution, ธุรกรรมเชิงปรัชญาของ Royal Society of London เอ 339 (1992) 521-553
- AM Maiden, JM Rodenburg, อัลกอริธึมการดึงเฟส ptychographical ที่ได้รับการปรับปรุงสำหรับการถ่ายภาพแบบเลี้ยวเบน, อัลตร้าไมโครสโคป, 109 (2009) 1256-1262
- H. Yang, I. MacLaren, L. Jones, GT Martinez, M. Simson, M. Huth, H. Ryll, H. Soltau, R. Sagawa, Y. Kondo, C. Ophus, P. Ercius, L. Jin , A. Kovács และ พีดี เนลลิส การถ่ายภาพเฟสอิเลคตรอน ptychographic ขององค์ประกอบแสงในวัสดุที่เป็นผลึกโดยใช้การกระจายตัวของวิกเนอร์ อัลตร้าไมโครสโคป 180 (2017) 173-179
สินค้าที่เกี่ยวข้อง
การแก้ปัญหาตามสาขา
คุณเป็นผู้เชี่ยวชาญทางการแพทย์หรือบุคลากรที่เกี่ยวข้องกับการรักษาพยาบาลหรือไม่?
ไม่
โปรดทราบว่าหน้าเหล่านี้ไม่ได้มีวัตถุประสงค์เพื่อให้ข้อมูลเกี่ยวกับผลิตภัณฑ์แก่ประชาชนทั่วไป
