การวิเคราะห์โครงสร้างของอุปกรณ์เซมิคอนดักเตอร์โดยใช้เอกซ์เรย์ STEM/EDS
JEOL NEWS ฉบับที่ 53 No.7
โยชิทากะ อาโอยามะ1, อิจิโร โอนิชิ1โนริอากิ เอนโดะ1, เออิจิ โอคุนิชิ1, ทาเคโอะ ซาซากิ2, โยริโนบุ อิวาซาวะ3, ยูกิฮิโตะ คอนโด1
1หน่วยธุรกิจ EM บริษัท JEOL Ltd. 2จอล (สหราชอาณาจักร) บจก. 3หน่วยธุรกิจ EC, JEOL Ltd.
เมื่อเร็วๆ นี้ อุปกรณ์เซมิคอนดักเตอร์ได้รับการออกแบบให้เป็นสถาปัตยกรรมการเรียงซ้อน 3 มิติ เพื่อประสิทธิภาพสูงและการผสานรวมในระดับสูง ดังนั้น การวิเคราะห์โครงสร้าง 3 มิติของอุปกรณ์เซมิคอนดักเตอร์ที่มีความละเอียดมิเตอร์ระดับนาโนจึงมีความสำคัญต่อการปรับปรุงอุปกรณ์เซมิคอนดักเตอร์ การตรวจเอกซเรย์ EDS กำลังได้รับความนิยมในการกำหนดลักษณะเฉพาะของตัวอย่างที่มีโครงสร้าง 3 มิติ เช่น อุปกรณ์เซมิคอนดักเตอร์หรือวัสดุที่เป็นโลหะ เนื่องจากวิธีนี้ช่วยให้เรามองเห็นการกระจายแบบ 3 มิติของสปีชีส์อะตอมของตัวอย่างได้ จำเป็นต้องเพิ่มความไวของการตรวจจับด้วยรังสีเอกซ์ เนื่องจากสัญญาณของรังสีเอกซ์ที่มีลักษณะเฉพาะมักจะอ่อนแอ เพื่อให้ได้รับสัญญาณเอ็กซ์เรย์เพิ่มเติมจากตัวอย่าง ได้มีการพัฒนาระบบตรวจจับเอ็กซ์เรย์พร้อมเครื่องตรวจจับ EDS สองตัว ในระบบ เครื่องตรวจจับจะถูกวางอย่างสมมาตรโดยสัมพันธ์กับแกนเอียงของตัวจับตัวอย่าง ดังนั้น รังสีเอกซ์ที่สร้างขึ้นบางส่วนจึงถูกบล็อกโดยตัวจับตัวอย่างหรือกริดรองรับ (ตาข่าย) ในช่วงมุมเอียงเฉพาะ เงาในการกำหนดค่านี้อาจทำให้เกิดสิ่งประดิษฐ์ในแผนที่องค์ประกอบ 3 มิติที่เป็นผลลัพธ์ เมื่อเร็วๆ นี้ เราได้พัฒนาระบบตรวจจับ EDS ใหม่ โดยวางเครื่องตรวจจับไว้บนแกนเอียงของระยะสุ่มตัวอย่าง เพื่อให้ได้ภาพโทโมแกรมของ EDS ที่ไม่มีการแรเงา ระบบได้รับการติดตั้งใน TEM 300 kV โทโมแกรม EDS จากตัวอย่างฟิล์มสีได้มาโดยใช้เครื่องตรวจจับ EDS ความเข้มของแผนที่ Ti Kα แต่ละแผนที่เกือบคงที่ตลอดช่วงการเอียงตัวอย่าง มีการบ่งชี้ว่าเครื่องตรวจจับ EDS ที่วางไว้ที่ตำแหน่งใหม่แทบไม่มีการปิดกั้น X-ray จากที่จับและตารางของตัวอย่าง แผนที่องค์ประกอบ 3 มิติของ FinFET ซึ่งเป็นหนึ่งในอุปกรณ์เซมิคอนดักเตอร์สมัยใหม่ ได้รับสำเร็จโดยใช้การกำหนดค่าเครื่องตรวจจับ EDS ใหม่
บทนำ
อุปกรณ์เซมิคอนดักเตอร์มีการใช้กันอย่างแพร่หลายในผลิตภัณฑ์อิเล็กทรอนิกส์ทั่วโลก ในอดีต อุปกรณ์เซมิคอนดักเตอร์ที่รวมความหนาแน่นสูงได้ถูกนำมาใช้โดยการลดขนาดทรานซิสเตอร์บนชิป เมื่อเร็วๆ นี้ อุปกรณ์เซมิคอนดักเตอร์ได้รับการออกแบบให้เป็นสถาปัตยกรรมการซ้อนสามมิติ (3D) เพื่อการผสานรวมและประสิทธิภาพสูง [1-2] การสังเกตการณ์ 3 มิติด้วยความละเอียดระดับนาโนเมตรเป็นสิ่งจำเป็นสำหรับการพัฒนาและการวิเคราะห์ความล้มเหลวของอุปกรณ์ใหม่ [3-4] Electron Tomography (ET) เป็นหนึ่งในวิธีการได้มาซึ่งโครงสร้าง 3 มิติของตัวอย่างที่มีความละเอียดระดับนาโน 3 มิติโดยใช้กล้องจุลทรรศน์อิเล็กตรอนแบบส่องผ่าน (TEM) การตรวจเอกซเรย์ EDS ทำได้โดยการผสานรวมกับเครื่องเอ็กซ์เรย์แบบกระจายพลังงาน (EDS) และ ET เพื่อให้ทราบลักษณะทางเคมี 3 มิติจากชุดของแผนที่ชุดองค์ประกอบแบบเอียง 2 มิติที่ถ่ายโดย TEM ที่ติดตั้งเครื่องตรวจจับ EDS [5-6] เทคนิคนี้ใช้กับอุปกรณ์เซมิคอนดักเตอร์ใหม่และวัสดุโลหะเพื่อสังเกตโครงสร้าง 3 มิติเหล่านี้ [7-11] เมื่อมีการรายงานผลการตรวจเอกซเรย์ EDS ครั้งแรกในปี พ.ศ. 2003 เครื่องตรวจจับ EDS ชนิดซิลิกอน-ลิเธียมซึ่งมีอัตราการนับวิเคราะห์ต่ำ มักใช้เพื่อให้ได้แผนที่ EDS ของปริมาณอิเล็กตรอนที่สูงและระยะเวลาในการได้มาซึ่งยาวนาน ดังนั้น เอกซ์เรย์ EDS จึงไม่มีประโยชน์สำหรับการวิเคราะห์องค์ประกอบ 3 มิติ เนื่องจากความเสียหายของลำแสงฉายรังสีและการปนเปื้อนบนตัวอย่าง แต่เมื่อไม่นานมานี้ เครื่องตรวจจับการเคลื่อนตัวของซิลิคอนขนาดใหญ่ (SDD) และระบบตรวจจับ EDS หลายระบบสำหรับ TEM ได้รับการพัฒนา [12] โดยใช้ระบบ SDD ใหม่ สามารถรับแผนที่ EDS ได้เร็วกว่าการใช้ระบบตรวจจับชนิดซิลิกอน-ลิเธียมประมาณ 13 เท่า [13] โทโมแกรม EDS จากวัสดุแข็งสามารถหาได้ง่ายโดยใช้ระบบ SDD แบบคู่ แม้ว่าจะยังเป็นเรื่องยากที่จะได้โทโมแกรมของ EDS จากวัสดุที่ไวต่อลำแสง เช่น ตัวอย่างชีวภาพ
การตรวจเอกซเรย์ EDS เป็นเครื่องมือที่มีประสิทธิภาพในการวิเคราะห์โครงสร้างองค์ประกอบ 3 มิติในเชิงคุณภาพ แต่การตรวจเอกซเรย์ EDS มีข้อจำกัดสองประเภทสำหรับการวิเคราะห์เชิงปริมาณ 3 มิติที่เกิดจากตำแหน่งสัมพัทธ์ของตัวอย่าง TEM และเครื่องตรวจจับ EDS [14] รูปที่ 1(a) แสดงผลการดูดซึม ซึ่งเป็นข้อจำกัดสำหรับการวิเคราะห์เชิงปริมาณในการตรวจเอกซเรย์คอมพิวเตอร์ EDS ลูกศรสีดำระบุเส้นทางของรังสีเอกซ์ที่เกิดจากอิเล็กตรอนตกกระทบ เมื่อโครงสร้างของตัวอย่างมีความสมมาตร จำนวนรวมของรังสีเอกซ์ที่สร้างขึ้นจากด้านใกล้และด้านไกลของเครื่องตรวจจับ EDS จะเท่ากัน อย่างไรก็ตาม รังสีเอกซ์ที่สร้างขึ้นจากด้านไกลนั้นสามารถดูดซับได้โดยตัวตัวอย่างเอง ด้วยเหตุนี้ รังสีเอกซ์ที่ตรวจพบจากด้านไกลจึงน้อยกว่ารังสีเอกซ์จากด้านใกล้ เอฟเฟกต์การดูดซึมสามารถทำให้เกิดสิ่งประดิษฐ์ในแผนที่องค์ประกอบ 3 มิติที่ได้ การศึกษาล่าสุดได้พยายามที่จะชดเชยผลการดูดซึมตัวเองโดยการคำนวณบนโทโมแกรม EDS ที่ได้รับ [15] รูปที่ 1(b) แสดงข้อจำกัดอื่น นั่นคือเอฟเฟกต์เงา โดยปกติ ตัวอย่าง TEM จะได้รับการแก้ไขบนกริด และคาดคาดไว้บนตัวยึดตัวอย่าง เมื่อเครื่องตรวจจับ EDS สองเครื่องตั้งอยู่อย่างสมมาตรโดยสัมพันธ์กับแกนเอียงของตัวจับยึดตัวอย่างในระบบ EDS ก่อนหน้า เครื่องเอ็กซ์เรย์ที่สร้างขึ้นบางส่วนจะถูกบล็อกโดยกริดหรือตัวจับตัวอย่างในช่วงมุมเอียงเฉพาะ เงาในการกำหนดค่านี้ยังสามารถทำให้เกิดสิ่งประดิษฐ์ในแผนที่องค์ประกอบ 3 มิติที่เป็นผลลัพธ์ เพื่อหลีกเลี่ยงเอฟเฟกต์การแรเงานี้ จำเป็นต้องแก้ไขความเข้มที่วัดได้ของแผนที่ EDS หลังจากการได้มา ตามประสิทธิภาพการตรวจจับที่คาดไว้หรือที่วัดไว้ล่วงหน้า สำหรับการวิเคราะห์เชิงปริมาณ 3 มิติ ต้องลบทั้งเอฟเฟกต์การดูดกลืนและเอฟเฟกต์เงาออกจากภาพโทโมแกรมของ EDS
การกำหนดค่า EDS-detector ก่อนหน้านี้แสดงในรูปที่ 2 (a) เครื่องตรวจจับ EDS อยู่ที่ทั้งสองด้านของแกนเอียง ในการกำหนดค่านี้ มุมทึบของ SDD จะแตกต่างกันไปตามมุมเอียง เราได้ปรับปรุงรูปแบบนี้โดยการกำหนดค่าตัวตรวจจับ EDS ใหม่ โดยวาง SDD บนแกนเอียง (รูปที่ 2(b)) เป็นที่คาดว่า SDD บนแกนเอียงไม่มีผลกระทบจากเงาในทุกช่วงมุมเอียงสำหรับการตรวจเอกซเรย์ EDS จุดประสงค์ของการศึกษานี้คือเพื่อให้ชัดเจนว่าการกำหนดค่าเครื่องตรวจจับ EDS แบบใหม่ไม่มีผลกระทบจากการแรเงาในเอกซ์เรย์ EDS และเพื่อให้ได้แผนที่องค์ประกอบเชิงปริมาณ 3 มิติจากอุปกรณ์เซมิคอนดักเตอร์
รูปที่ 1 แผนผังไดอะแกรมของข้อจำกัดสองประการสำหรับการวิเคราะห์เชิงปริมาณ 3 มิติในการตรวจเอกซเรย์ EDS
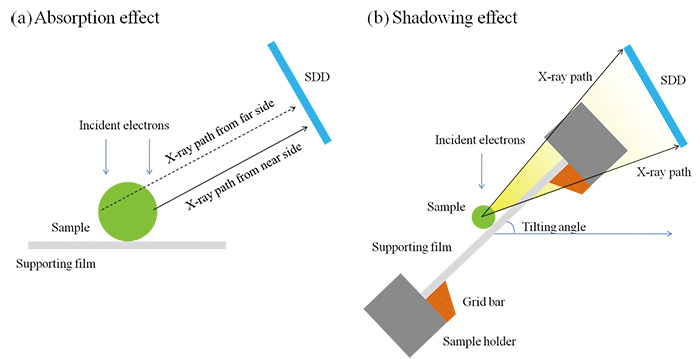
- ผลการดูดซึมโดยตัวอย่าง รังสีเอกซ์จากด้านไกลของตัวอย่างจะถูกดูดกลืนโดยตัวตัวอย่างมากกว่าด้านใกล้
- เอฟเฟกต์เงาโดยผู้ถือตัวอย่าง รังสีเอกซ์จากตัวอย่างถูกบล็อกโดยตัวจับตัวอย่างหรือแท่งกริดในช่วงมุมเอียงเฉพาะ ลูกศรสีดำแสดงเส้นทางรังสีไปยังเครื่องตรวจจับ EDS
Fig.2

- ระบบตรวจจับ EDS รุ่นก่อน ซึ่งประกอบด้วย SDD สองชุดที่วางตำแหน่งแบบสมมาตร อันหนึ่งอยู่ทางด้านขวาของแกนเอียงและอีกอันอยู่ฝั่งตรงข้าม
- การกำหนดค่าใหม่ของระบบตรวจจับ EDS นอกจากนี้ยังมี SDD สองชุด และเพิ่ม SDD2 ลงในแกนเอียง เป็นที่คาดหวังที่จะได้รับโทโมแกรม EDS เชิงปริมาณที่ไม่มีเอฟเฟกต์แชโดว์โดยใช้ SDD2 เท่านั้นสำหรับการตรวจเอกซเรย์ EDS
การทดลอง
กล้องจุลทรรศน์ที่ใช้สำหรับการทดลองของเราคือการแก้ไขความคลาดเคลื่อน 300 kV TEM (JEM-ARM300F, JEOL Ltd.) พร้อมกับ SDD สองชุด (ดูรูปที่ 3) เครื่องตรวจจับหนึ่งตัวตั้งอยู่บนแกนเอียงของตัวจับตัวอย่าง (SDD2) และอีกตัวหนึ่งอยู่ที่ด้านขวาของแกนเอียง (SDD1) (รูปที่ 2(b)) เพื่อให้ได้ภาพโทโมแกรม EDS อย่างรวดเร็วโดยไม่มีเอฟเฟกต์เงาโดยใช้ SDD2 เท่านั้น จึงใช้ TEM ขนาด 300 kV ที่มีชิ้นขั้วใหม่ ตัวจับยึดแบบเอียงสูงเชิงวิเคราะห์แบบใหม่ และ SDD ขนาดใหญ่ ชิ้นขั้วใหม่ ซึ่งมีชื่อว่าชิ้นส่วนขั้วช่องว่างกว้าง (WGP) ได้รับการออกแบบให้บางกว่าชิ้นขั้วก่อนหน้า เพื่อให้เครื่องตรวจจับ EDS สามารถเข้าใกล้ที่ใส่ตัวอย่างได้ ความละเอียดเชิงพื้นที่ของ 300 kV TEM พร้อม WGP คือ 0.062 นาโนเมตร เนื่องจากตัวแก้ไขความคลาดเคลื่อน Cs ตัวจับยึดแบบเอียงสูงเชิงวิเคราะห์รุ่นใหม่ได้รับการพัฒนาสำหรับการตรวจเอกซเรย์ EDS ปลายของตัวยึดนี้แคบและบางเพื่อให้เอ็กซ์เรย์ที่สร้างขึ้นไม่ถูกปิดกั้นสำหรับการตรวจเอกซเรย์ EDS ด้วยการใช้เอกสารแนบและ SDD ขนาดใหญ่เหล่านี้ ซึ่งมีพื้นที่การตรวจจับ 158 มม.2 ทำให้มุมทึบของ SDD2 เท่านั้นถึงมากกว่า 1.1 วินาที ระบบตรวจจับ EDS ของเราสามารถให้ความละเอียดเชิงพื้นที่สูงและอัตราการนับเชิงวิเคราะห์สูง แม้จะใช้เครื่องมือตรวจจับเพียงตัวเดียว [13]
เราเตรียมตัวอย่างสองประเภทสำหรับการทดลองของเรา หนึ่งคือตัวอย่างฟิล์มสีเพื่อประเมินเอฟเฟกต์การแรเงาในระบบตรวจจับ EDS ใหม่ อีกตัวหนึ่งคือทรานซิสเตอร์ชนิด Fin-type field (FinFET) ซึ่งเป็นหนึ่งในอุปกรณ์เซมิคอนดักเตอร์ที่ทันสมัย ฟิล์มสีส่วนใหญ่ซึ่งฝังด้วยอีพอกซีเรซิน ถูกตัดด้วยไมโครโทมี่ให้มีความหนา 200 นาโนเมตร ส่วนที่บางถูกติดตั้งบนเมมเบรนที่รองรับของกริดแท่งบางที่มีเส้นผ่านศูนย์กลาง 3 มม. ได้แผนที่ 2D EDS โดยใช้ TEM 300 kV พร้อมกระแสโพรบที่ 300 pA ชุดแผนที่ EDS แบบปรับเอียงได้ตั้งแต่ -60 ถึง +60 องศาโดยเพิ่มขึ้น 5 องศาได้รับมาโดยอัตโนมัติโดยซอฟต์แวร์เอกซเรย์คอมพิวเตอร์ (TEMography, SYSTEM IN FRONTIER Inc.) ซึ่งติดตั้งในพีซีควบคุมสำหรับ TEM ขนาดของแต่ละแผนที่ EDS คือ 256 x 256 พิกเซล ขนาดพิกเซล 9.766 นาโนเมตร/พิกเซล เวลาในการเข้าซื้อกิจการคือ 190 นาที แผนที่ EDS ทั้งหมดที่ถ่ายในการทดลองของเราได้รับการแปลเป็นแผนที่การนับสุทธิจากแผนที่การนับเงาที่มีเงื่อนไขเดียวกันโดยใช้การประมวลผลแบบกลุ่มในซอฟต์แวร์ตัววิเคราะห์ EDS (Analysis StationTM, JEOL Ltd.) ในตอนเริ่มต้นของขั้นตอนการสร้างใหม่ ชุดการเอียงของรูปภาพ HAADF-STEM ถูกจัดแนวด้วยเครื่องหมาย fiducial และโครงสร้าง 3 มิติที่ไม่มีข้อมูลองค์ประกอบจะถูกสร้างขึ้นใหม่ อัลกอริธึมการสร้างใหม่ 3 มิติสำหรับการสร้างใหม่นี้เป็นเทคนิคการสร้างซ้ำแบบวนซ้ำพร้อมกัน (SIRT) ทั้งเงื่อนไขการจัดตำแหน่งเดียวกันและสภาพการสร้างใหม่เหมือนกันถูกนำไปใช้กับซีรีย์การเอียงของ EDS โดยใช้การประมวลผลแบบกลุ่มในซอฟต์แวร์ TEMography ในที่สุด เราก็ได้แผนที่องค์ประกอบ 3 มิติของตัวอย่างฟิล์มสี
ตัวอย่าง FinFET ถูกตัดอย่างคร่าวๆ โดยเลื่อยวงล้อเพชรความเร็วต่ำ ส่วนของตัวอย่างถูกทำให้บางลงโดยการขัดด้วยกลไก ในที่สุด ตัวอย่างถูกสีด้วยเครื่องกัดไอออนอาร์กอน (Ion SlicerTM, JEOL Ltd.) เพื่อการสังเกต TEM [16] อนุภาคคอลลอยด์สีทองที่มีขนาดเส้นผ่านศูนย์กลาง 5 นาโนเมตร ถูกหย่อนลงบนตัวอย่างและใช้เป็นเครื่องหมายระบุตำแหน่งสำหรับการจัดตำแหน่งชุดเอียง TEM ทำงานที่แรงดันไฟฟ้าเร่ง 200 kV ชุดการเอียงของแผนที่องค์ประกอบ EDS ได้รับมาโดยอัตโนมัติในช่วงมุมเอียงตั้งแต่ +64 ถึง -64 องศา องศาขั้นคือ 4 องศา ขนาดของแต่ละแผนที่ EDS คือ 256 x 256 พิกเซล ขนาดพิกเซล 1.953 นาโนเมตร/พิกเซล ความหนาแน่นกระแสคือ 300 pA ใช้เวลารวมทั้งสิ้นประมาณ 120 นาทีโดยใช้ SDD เดียว (SDD2) ขั้นตอนการสร้างใหม่ของตัวอย่าง FinFET เหมือนกับตัวอย่างฟิล์มสี
Fig.3

- 300 kV TEM (JEM-ARM300F, JEOL Ltd.) พร้อม SDD ขนาดใหญ่สองตัวที่แสดงใน (b)
- พื้นที่การตรวจจับคือ 158 mm2.
- ตัวจับยึดเชิงวิเคราะห์ที่มีความลาดเอียงสูงที่พัฒนาขึ้นสำหรับการตรวจเอกซเรย์ EDS ปลายของตัวยึดจะแคบและบางกว่าแบบมาตรฐาน เพื่อไม่ให้บังรังสีเอกซ์ที่สร้างขึ้น
ผลลัพธ์และการสนทนา
ได้ภาพโทโมแกรม EDS จากตัวอย่างฟิล์มสีเพื่อประเมินเอฟเฟกต์เงาในระบบตรวจจับ EDS ใหม่ ซึ่งได้รับการติดตั้งใน 300 kV TEM รูปภาพ HAADF และแผนที่องค์ประกอบ 3 มิติแสดงไว้ในภาพที่ 4 ตัวอย่างฟิล์มสีที่ประกอบด้วยอนุภาคไททาเนียมออกไซด์ อนุภาคซิลิกาขนาดเล็ก อนุภาคเหล็กออกไซด์ขนาดเล็ก และเรซินคาร์บอนถูกทำเครื่องหมายด้วยสีเหลือง สีเขียว สีม่วงแดง และสีน้ำเงินในรูปที่ 4 (ข) ตามลำดับ ความเข้มรวมที่วัดได้ของ Ti Kαจากแผนที่ EDS ของตัวอย่างฟิล์มสีจะถูกพล็อตเทียบกับมุมเอียงของขั้นตัวอย่างใน TEM จุดสีแดง สีน้ำเงิน และสีเขียวที่แสดงในรูปที่ 5 สอดคล้องกับความเข้มทั้งหมดที่ตรวจพบโดย SDD1, SDD2 และ SDD1+SDD2 ตามลำดับ เนื่องจากปริมาตรของอนุภาคไททาเนียมออกไซด์ในแต่ละแผนที่ EDS นั้นคงที่ ความเข้มรวมจากแผนที่ Ti Kαจึงต้องคงที่ในผลลัพธ์ของการวิเคราะห์ EDS เชิงปริมาณ อย่างไรก็ตาม ความเข้มที่ตรวจพบโดย SDD1 และ SDD1+SDD2 ลดลงประมาณ -20 องศาจากเอฟเฟกต์การแรเงา ในทางกลับกัน ความเข้มที่ SDD2 ตรวจพบนั้นเกือบจะคงที่ตลอดช่วงการเอียงของตัวอย่าง ผลลัพธ์นี้บ่งชี้ว่าเครื่องตรวจจับ EDS ที่อยู่บนแกนเอียงแทบไม่มีการปิดกั้นรังสีเอกซ์จากตัวยึดและตารางของตัวอย่าง ระบบเอกซ์เรย์ EDS ที่แทบไม่มีเงาเกิดขึ้นได้โดยใช้เครื่องตรวจจับ EDS เครื่องเดียวนี้
ระบบเอกซ์เรย์ EDS แบบไม่มีเงาถูกนำไปใช้กับอุปกรณ์เซมิคอนดักเตอร์ ภาพ HAADF และแผนที่ชุดเอียง EDS ของ FinFET ได้มาจาก 300 kV TEM ที่แสดงในรูปที่ 6 จุดสีขาวในภาพ HAADF สอดคล้องกับอนุภาคนาโนทองคำซึ่งถูกใช้เป็นผู้สร้าง fiducial สำหรับการจัดตำแหน่งในแบบ 3 มิติ ขั้นตอนการฟื้นฟู แผนที่องค์ประกอบ 3 มิติของ FinFET ที่แสดงในรูปที่ 6 ถูกสร้างขึ้นใหม่โดยใช้อัลกอริธึม SIRT ในแผนที่ผลลัพธ์ ตรวจพบเจอร์เมเนียม ไททาเนียม ทังสเตน ออกซิเจน ไนโตรเจน และซิลิกอน โครงสร้าง 3 มิติของเกตอิเล็กโทรดบนพื้นผิวซิลิกอนนั้นสังเกตได้ชัดเจนโดยการตรวจเอกซเรย์ EDS แผนที่ไนโตรเจน 3 มิติที่สอดคล้องกับฟิล์มฉนวนยังคงมีเสียงดัง ปริมาณอิเล็กตรอนที่สูงขึ้นหรือเวลาในการได้มาซึ่งนานขึ้นเป็นสิ่งจำเป็นในการสังเกตการกระจายองค์ประกอบ 3 มิติขององค์ประกอบแสงที่มีอัตราส่วนสัญญาณต่อสัญญาณรบกวนสูง แม้จะใช้ SDD ที่มีความไวสูง 158 mm2 รูปที่ 7 แสดงการแบ่งส่วนปกติของทิศทาง X, Y และ Z ที่ดึงมาจากแผนที่ปริมาตรองค์ประกอบ 3 มิติที่ได้รับ ตำแหน่งของแผนผังส่วน Y-cut จะถูกระบุด้วยเส้นสีเหลืองในแผนที่ Z-slice ที่เกี่ยวข้องซึ่งแสดงด้านล่างแผนผัง Y-cut ตัวสร้างความเครียดเจอร์เมเนียม (สีเหลือง) อิเล็กโทรดทังสเตน (สีเขียว) และช่องซิลิกอน (สีน้ำเงิน) มองเห็นได้ชัดเจนในแผนผัง Y-cut slice (a) และไนโตรเจน (สีม่วงแดง) ที่อยู่ระหว่างช่องสัญญาณและอิเล็กโทรดได้มาจากแผนที่องค์ประกอบ 3 มิติ จากผลลัพธ์เหล่านี้ เราสามารถสรุปได้ว่าการตรวจเอกซเรย์ EDS มีประโยชน์ในการวิเคราะห์โครงสร้างองค์ประกอบ 3 มิติของอุปกรณ์เซมิคอนดักเตอร์สมัยใหม่
ในการศึกษานี้ เราพยายามลบเอฟเฟกต์การแรเงาในการตรวจเอกซเรย์ EDS โดยปรับปรุงการกำหนดค่าตัวตรวจจับใน TEM อย่างไรก็ตาม ผลการดูดกลืนยังต้องถูกลบออกสำหรับการวิเคราะห์เชิงปริมาณ 3 มิติ เมื่อตัวอย่างประกอบด้วยองค์ประกอบแสงร่วมกับองค์ประกอบหนัก ผลกระทบของการดูดกลืนมีความรุนแรงในการวิเคราะห์องค์ประกอบ 3 มิติเชิงปริมาณโดยการตรวจเอกซเรย์คอมพิวเตอร์ EDS เราได้ประเมินผลของการดูดกลืนรังสีเอกซ์โดยตัวอย่างฟิล์มสีในเอกซ์เรย์ EDS ชุดข้อมูลโทโมแกรม EDS ถ่ายโดย TEM ขนาด 200 kV (JEM-F200, JEOL Ltd.) ที่ติดตั้ง SDD สองชุดซึ่งอยู่บนแกนเอียงและด้านขวาของที่จับตัวอย่างตามลำดับ แผนที่องค์ประกอบ 3 มิติของไททาเนียม เหล็ก อลูมิเนียม ซิลิกอน ออกซิเจน และคาร์บอน ถูกสร้างขึ้นใหม่จากแผนที่ชุดเอียงของ EDS ของตัวอย่างฟิล์มสี อัตราส่วนองค์ประกอบกับ voxel โดย voxel คำนวณโดยใช้วิธี Cliff-Lorimer เราได้เปรียบเทียบอัตราส่วนองค์ประกอบ 3 มิติจากอนุภาคไททาเนียมไดออกไซด์ทั้งสามซึ่งระบุด้วยลูกศรสีเหลืองในรูปที่ 8 อัตราส่วนองค์ประกอบ 3 มิติจากอนุภาคที่มีขนาดเส้นผ่าศูนย์กลาง 115 นาโนเมตรนั้นสอดคล้องกับข้อเท็จจริงที่ว่าอนุภาคนั้นเป็นไททาเนียมไดออกไซด์ แต่เปอร์เซ็นต์อะตอมของออกซิเจนในอนุภาคที่มีเส้นผ่านศูนย์กลาง 190 นาโนเมตรและ 315 นาโนเมตรนั้นถูกประเมินต่ำไป ก็ถือว่าเอกซเรย์จากออกซิเจนนั้นถูกดูดกลืนโดยตัวอย่างเอง การแก้ไขเอฟเฟกต์การดูดกลืนเป็นที่ต้องการเพื่อวิเคราะห์การกระจายองค์ประกอบเชิงปริมาณ 3 มิติด้วยความแม่นยำสูงในการตรวจเอกซเรย์ EDS
Fig.4

- ภาพ HAADF ของตัวอย่างฟิล์มสี ถ่ายโดย JEM-ARM300F ที่ติดตั้งเครื่องตรวจจับ EDS ซึ่งมีพื้นที่ตรวจจับ 158 มม.2
- ภาพ 3 มิติที่สร้างขึ้นใหม่จากตัวอย่างที่แสดงใน (ก) สีบ่งบอกถึงชนิดของอะตอม: สีเหลือง (Ti), สีเขียว (Si), สีม่วงแดง (Fe) และสีน้ำเงิน (c)
Fig.5

ความเข้มรวมของแผนที่ Ti Kα ของตัวอย่างฟิล์มสีโดยใช้สัญญาณเครื่องตรวจจับที่แตกต่างกันซึ่งวางแผนเทียบกับมุมเอียง จุดสีน้ำเงิน จุดสีแดง และจุดสีเขียวสอดคล้องกับ Ti Kα แผนที่ที่สร้างโดยสัญญาณของ SDD1, SDD2 และ SDD1+SDD2 ตามลำดับ ความเข้มที่ตรวจพบโดย SDD2 นั้นเกือบคงที่ตลอดช่วงการเอียงตัวอย่างสำหรับ ET
Fig.6
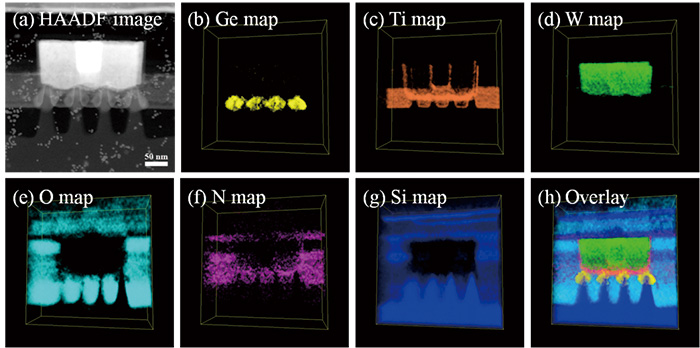
(a) รูปภาพ HAADF ของตัวอย่าง FinFET ที่ถ่ายโดย JEM-ARM300F ที่ติดตั้ง SDD ขนาดใหญ่เพียงตัวเดียวซึ่งมีพื้นที่การตรวจจับ 158 มม.2. จุดสีขาวสอดคล้องกับอนุภาคนาโนสีทองที่ใช้เป็นเครื่องหมายระบุตำแหน่ง (b)-(h) แผนที่องค์ประกอบ 3 มิติของตัวอย่างเดียวกันใน (a) สร้างขึ้นใหม่จากแผนที่อนุกรมเอียงของ EDS ซึ่งแสดงการกระจายของเจอร์เมเนียม ไททาเนียม ทังสเตน ออกซิเจน ไนโตรเจน และอะตอมซิลิกอน ตามลำดับ ตัวอย่างถูกทำให้บางลงโดยการกัดด้วยไอออน ขนาดของปริมาตรที่สร้างใหม่คือ (381, 377, 121) นาโนเมตร
Fig.7

แผนที่สไลซ์ Y-cut และ Z-cut ที่ดึงมาจากแผนที่ปริมาตรองค์ประกอบ 3 มิติที่สร้างขึ้นใหม่ของตัวอย่าง FinFET โดยใช้การตรวจเอกซเรย์ EDS (a) และ (b) แสดงแผนที่องค์ประกอบของชิ้นตัด Y ที่ตำแหน่งต่างๆ ที่ระบุโดยเส้นสีเหลืองในแผนที่ส่วนตัด Z ที่สอดคล้องกันด้านล่าง Z-cut สไลซ์ขนานกับพื้นผิวเวเฟอร์ ตัวสร้างความเครียดเจอร์เมเนียม อิเล็กโทรดทังสเตน และช่องซิลิกอนและพื้นผิวมีสีเหลือง สีเขียว และสีน้ำเงินตามลำดับ
Fig.8
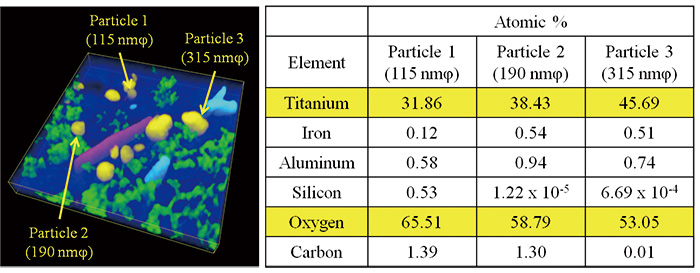
แผนที่องค์ประกอบ 3 มิติของตัวอย่างฟิล์มสีที่สร้างใหม่โดยโทโมแกรม EDS ที่ได้รับโดยใช้ JEM-F200 ที่ติดตั้ง SDD ขนาด 100 มม.2 พื้นที่การตรวจจับ (รูปด้านซ้าย) การวิเคราะห์เชิงปริมาณ 3 มิติของอนุภาคไททาเนียมไดออกไซด์ 2 ตัวที่ระบุโดยลูกศรสีเหลืองแสดงในตารางด้านขวา อัตราส่วนองค์ประกอบของออกซิเจนในอนุภาค 3 และ XNUMX ถูกประเมินต่ำเกินไปเนื่องจากผลการดูดกลืนรังสีเอกซ์ ไม่สามารถละเลยผลการดูดซึมสำหรับการวิเคราะห์เชิงปริมาณในการตรวจเอกซเรย์ EDS
สรุป
เพื่อให้ได้การวิเคราะห์องค์ประกอบ 3 มิติเชิงปริมาณ เราได้พัฒนาระบบตรวจจับ EDS ใหม่สำหรับ TEM และติดตั้งระบบเพื่อแก้ไขค่าความคลาดเคลื่อน 300 kV TEM ระบบตรวจจับประกอบด้วยตัวตรวจจับ EDS สองตัวที่มีการกำหนดค่าต่างกัน ซึ่งวางอยู่บนแกนเอียงของแท่นสุ่มตัวอย่าง (SDD2) และทางด้านขวาของแกนเอียง (SDD1) พื้นที่การตรวจจับของ SDD เหล่านี้คือ 158 mm2. นอกจากนี้ เราได้พัฒนาตัวจับยึดเชิงวิเคราะห์ที่มีความลาดเอียงสูงซึ่งส่วนปลายจะแคบกว่าและบางกว่าตัวจับยึดมาตรฐานเพื่อให้การเอ็กซ์เรย์ที่สร้างขึ้นจากตัวอย่างไม่ถูกปิดกั้น ด้วยการใช้กล้องจุลทรรศน์นี้กับสิ่งที่แนบมาเหล่านี้ มุมทึบของ SDD1 และ SDD2 จะเท่ากับ 1.106 sr และ 1.108 sr ตามลำดับ ได้ภาพเอกซเรย์ EDS จากตัวอย่างฟิล์มสีโดยใช้ระบบตรวจจับ EDS ใหม่ ความเข้มรวมจาก Ti Kα แผนที่ของฟิล์มสีนั้นเกือบจะคงที่ตลอดช่วงการเอียงตัวอย่างสำหรับการตรวจเอกซเรย์ ผลการวิจัยพบว่าระบบตรวจจับ EDS ใหม่สามารถรับโทโมแกรม EDS ได้โดยไม่มีเอฟเฟกต์เงา แผนที่องค์ประกอบ 3 มิติจาก FinFET ได้มาโดยไม่มีเอฟเฟกต์เงาโดยใช้ระบบตรวจจับ EDS ใหม่ เอฟเฟกต์เงาสามารถลบออกได้โดยการกำหนดค่าการตรวจจับ EDS ของเรา การแก้ไขเอฟเฟกต์การดูดกลืนเป็นที่ต้องการเพื่อวิเคราะห์การกระจายองค์ประกอบเชิงปริมาณ 3 มิติด้วยความแม่นยำสูงในการตรวจเอกซเรย์ EDS
อ้างอิง
- D. Hisamoto, WC Lee, J. Kedzierski, E. Anderson, H Takeuchi, K Asano, TJ King, J. Bokor และ C. Hu, "A folded-channel MOSFET for deep-sub-tenth micron era", IEDM Tech . ขุด, (1998) หน้า 1032-1034.
- H. Tanaka, M. Kido, K. Yahashi, M. Oomura, R. Katsumata, M. Kito, Y. Fukuzumi, M. Sato, Y. Nagata, Y. Matsuoka, "Bit Cost Scalable Technology with Punch and Plug Process for Ultra High Density Flash Memory" การดำเนินการของ Symposium on VLSI Technology, (2007) pp. 14-15.
- AM Cormack, "การแสดงแทนฟังก์ชันโดยปริพันธ์, พร้อมการประยุกต์ทางรังสีบางอย่าง", เจ. ฟิสิกส์ประยุกต์, 34 (1963) หน้า 2722-2727
- M. Hayashida, L. Gunawan, M. Malac, C. Pawlowicz และ M. Couillard, "การตรวจเอกซเรย์อิเล็กตรอนที่มีความแม่นยำสูงของอุปกรณ์เซมิคอนดักเตอร์", ไมโครสก. Microanal . 21, 3 (2015) หน้า 1609-1610.
- B. Fu, M. Gribelyuk, L. Dumas, C. Fang, N. LaManque, L. Hodgkins และ E. Chen, "การรวมกันของ STEM Tomography และ STEM/EDS ของ NiSi Formation Related Defects ใน Semiconductor Wafer-foundries" , ไมโครสก. Microanal . 22, 3 (2016)
- K. Lepinay, F. Lorut, R. Pantel และ T. Epicier, "เคมี 3D tomography ของ 28 nm high K metal gate transistor: STEM XEDS วิธีการทดลองและผลลัพธ์", ไมครอน 47 (2013) หน้า 43‒49.
- P. Burdet, J. Vannod, A. Hessler-Wyser, M. Rappaz และ M. Cantoni, "การวิเคราะห์ทางเคมีสามมิติของลวดเหล็กกล้าไร้สนิม NiTi-stainless ที่เชื่อมด้วยเลเซอร์โดยใช้ FIB แบบลำแสงคู่", แอ็คท่ามาแตร์., 61, 8 (2013) หน้า 3090–3098.
- A. Genc, L. Kovarik, M. Gu, H. Cheng, P. Plachinda, L. Pullan, B. Freitag และ C. Wang, "XEDS STEM tomography สำหรับการแสดงลักษณะทางเคมี 3 มิติของอนุภาคระดับนาโน", อัลตร้าไมโครสโคป 131 (2013) หน้า 24‒32.
- B. Goris, L. Polavarapu, S. Bals, G. Van Tendeloo และ L. Liz-Marzan, "การตรวจสอบการแทนที่กัลวานิกผ่านการทำแผนที่ทางสัณฐานวิทยาและเคมีสามมิติ", นาโน เล็ตต์ . 14, 6 (2014) น. 3220‒3226.
- G. Möbus, R. Doole, B. Inkson, "เอกซเรย์อิเล็กตรอนแบบสเปกโตรสโกปี", อัลตร้าไมโครสโคป, 96, 3‒4 (2003) น. 433‒451.
- Z. Saghi, X. Xu, Y. Peng, B. Inkson และ G. Möbus, "การวิเคราะห์ทางเคมีสามมิติของโพรบทังสเตนโดยนาโนโทโมกราฟีเอ็กซ์เรย์แบบกระจายพลังงาน", แอปพลิเค สรีรวิทยา เลตต์. 91 (2007) น. 25.
- L. Strueder, P. Lechner และ P. Leutenegger, "ตัวตรวจจับการล่องลอยของซิลิคอน ̶กุญแจสู่การทดลองใหม่", นาตูร์วิสเซินชาฟเตน 85, 11 (1998) น. 539‒543.
- I. Ohnishi, K. Miyatake, Y. Jimbo, Y. Iwasawa, M. Morita, T. Sasaki, H. Sawada และ E. Okunishi, "ระบบตรวจจับเอ็กซ์เรย์ที่มีประสิทธิภาพสูงของ SDD ขนาดใหญ่มากสองตัวสำหรับการแก้ไขความคลาดเคลื่อน 300 kV Microscope", Proceedings of Microscopy & Microanalysis 2016, 22, S3 (2016) pp. 318-319.
- CSM Yeoh, D. Rossouw, Z. Saghi, P. Burdet, RK Leary และ PA Midgley, "ด้านมืดของ EDX Tomography: Modeling Detector Shadowing to Aid 3D Elemental Signal Analysis", ไมโครสก. Microanal. 21, 3 (2015) น. 759‒764.
- Pierre Burdet, Z. Saghi, AN Filippin, A. Borrás และ PA Midgley, "วิธีการแก้ไขการดูดกลืน 3 มิติแบบใหม่สำหรับการตรวจเอกซเรย์ EDX-STEM เชิงปริมาณ", อัลตร้าไมโครสโคป 160 (2016) หน้า 118‒129.
- ก. ยาสุฮาระ "การพัฒนาเครื่องตัดไอออน (อุปกรณ์เตรียมตัวอย่างฟิล์มบาง)" ข่าว JEOL 40 (2005) หน้า 46-49
สินค้าที่เกี่ยวข้อง
คุณเป็นผู้เชี่ยวชาญทางการแพทย์หรือบุคลากรที่เกี่ยวข้องกับการรักษาพยาบาลหรือไม่?
ไม่
โปรดทราบว่าหน้าเหล่านี้ไม่ได้มีวัตถุประสงค์เพื่อให้ข้อมูลเกี่ยวกับผลิตภัณฑ์แก่ประชาชนทั่วไป
