โซลูชั่นใหม่สำหรับการเตรียมชิ้นงานทดสอบ
JIB-PS500i มีสามโซลูชั่นเพื่อช่วยในการเตรียมชิ้นงานทดสอบ TEM มั่นใจได้กับเวิร์กโฟลว์ปริมาณงานสูงตั้งแต่การเตรียมชิ้นงานจนถึงการสังเกต TEM
คุณสมบัติ

TEM-เชื่อมโยง
การใช้คาร์ทริดจ์แบบ double-tilt ของ JEOL และที่จับ TEM* ช่วยอำนวยความสะดวกในการเชื่อมโยงระหว่าง TEM และ FIB สามารถติดตั้งคาร์ทริดจ์เข้ากับตัวจับชิ้นงานทดสอบ TEM เฉพาะด้วยการสัมผัสเพียงครั้งเดียว
●ขั้นตอนการถ่ายโอนชิ้นงานด้วยตลับเอียงคู่*

* เป็นตัวเลือก
●ออมนิโพรบ 400*

OmniProbe 400* (Oxford Instruments) ที่นำมาใช้ช่วยให้สามารถหยิบจับชิ้นงานได้อย่างแม่นยำและราบรื่น การทำงานของ OmniProbe 400* รวมอยู่ในซอฟต์แวร์สำหรับ JIB-PS500i

ตัวอย่าง: อุปกรณ์เซมิคอนดักเตอร์กฎการออกแบบ 5 นาโนเมตร (FinFET)
เงื่อนไขการสังเกต: (ซ้าย) แรงดันเร่ง 2 kV, ภาพอิเล็กตรอนรองของเครื่องตรวจจับ SED,
(กลางและขวา) แรงดันไฟเร่ง 200 kV, ภาพ TEM, เครื่องมือ: JEM-ARM200F
ตรวจสอบและดำเนินการ
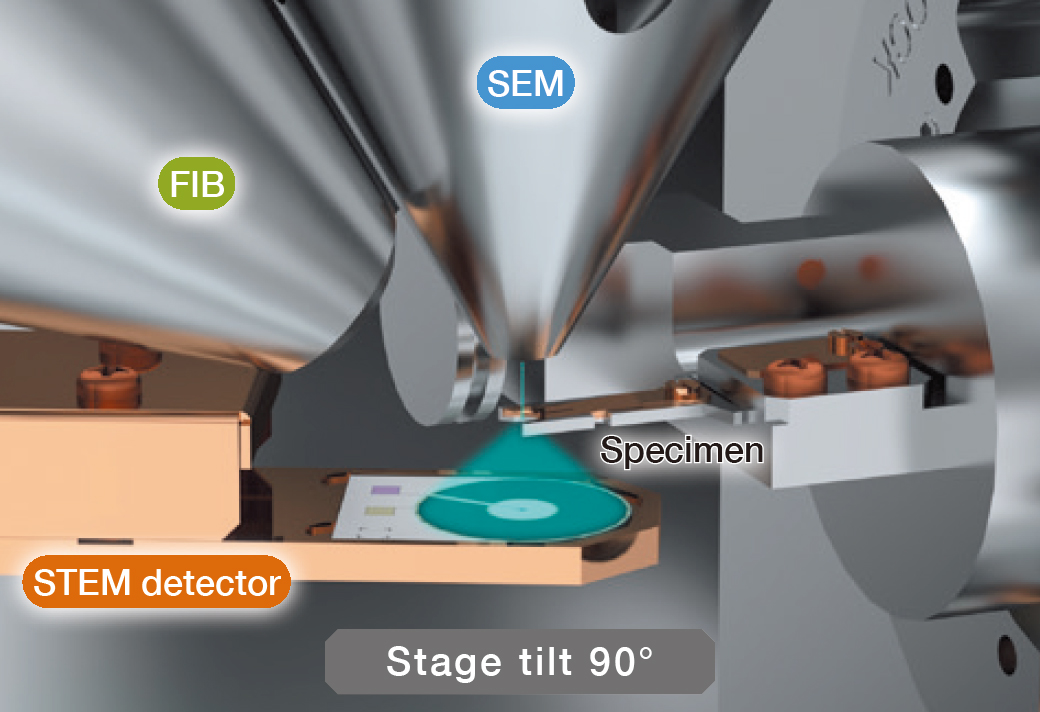
ในการเตรียมชิ้นงานทดสอบ TEM อย่างแม่นยำและมีประสิทธิภาพ จำเป็นต้องตรวจสอบความคืบหน้าในการเตรียมอย่างรวดเร็ว ด้วยระยะเอียงสูงและรูปแบบเครื่องตรวจจับ JIB-PS500i ช่วยให้สามารถเปลี่ยนจากการกัด FIB เป็นการถ่ายภาพด้วยกล้องจุลทรรศน์อิเล็กตรอนแบบส่องผ่าน (STEM) แบบสแกนได้อย่างราบรื่น การเปลี่ยนอย่างรวดเร็วระหว่างการประมวลผลแผ่นลาเมลลาและการสร้างภาพ STEM นำไปสู่การเตรียมชิ้นงานอย่างมีประสิทธิภาพ
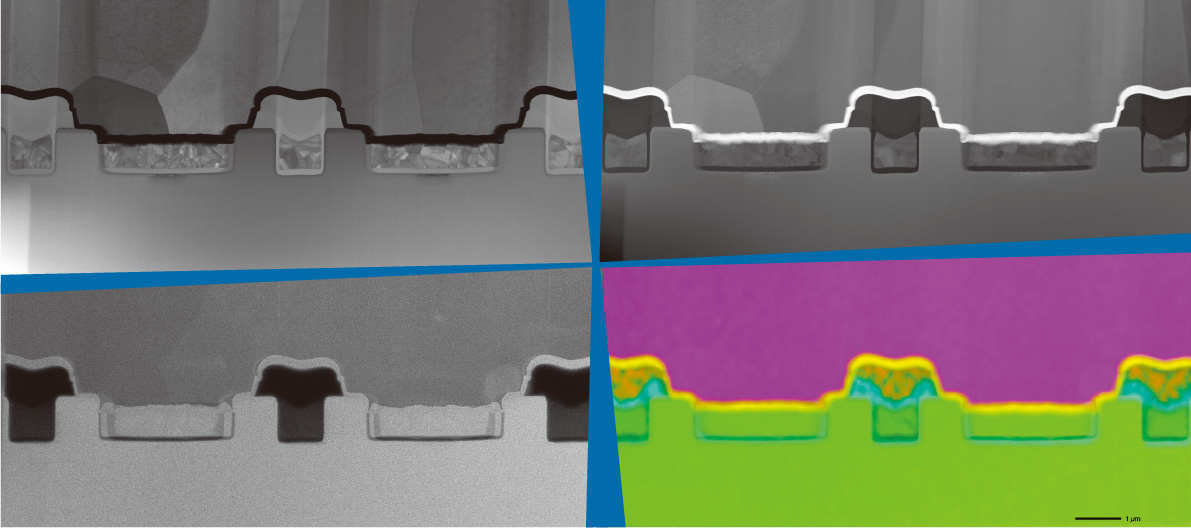
ตัวอย่าง: อุปกรณ์เซมิคอนดักเตอร์ไฟฟ้า SiC เงื่อนไขการสังเกต: แรงดันเร่ง 30 kV,
ตัวตรวจจับ (บนซ้าย) STEM-BF, (บนขวา) STEM-DF, (ซ้ายล่าง) SED ภาพอิเล็กตรอนทุติยภูมิ,
(ขวาล่าง) แผนที่ EDS สีม่วง: Al Yellow: Ti Orange: P Blue: O Green: Si
การเตรียมการอัตโนมัติ
JIB-PS500i เตรียมชิ้นงานทดสอบโดยอัตโนมัติโดยใช้ระบบเตรียมชิ้นงานทดสอบ TEM อัตโนมัติ STEMPLING2* ระบบอัตโนมัตินี้ช่วยให้ผู้ปฏิบัติงานสามารถเตรียมชิ้นงานสำหรับ TEM ได้อย่างราบรื่น
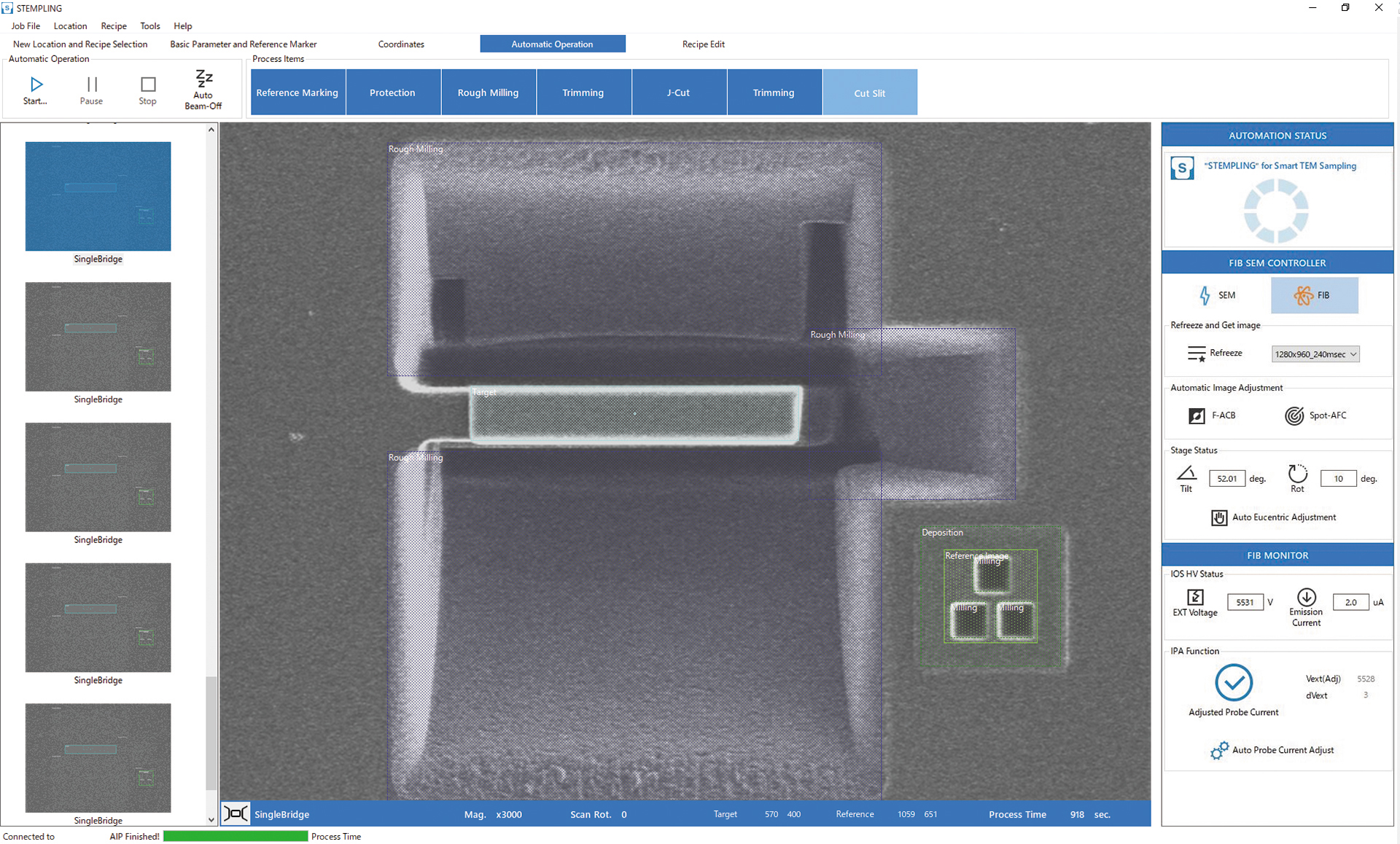
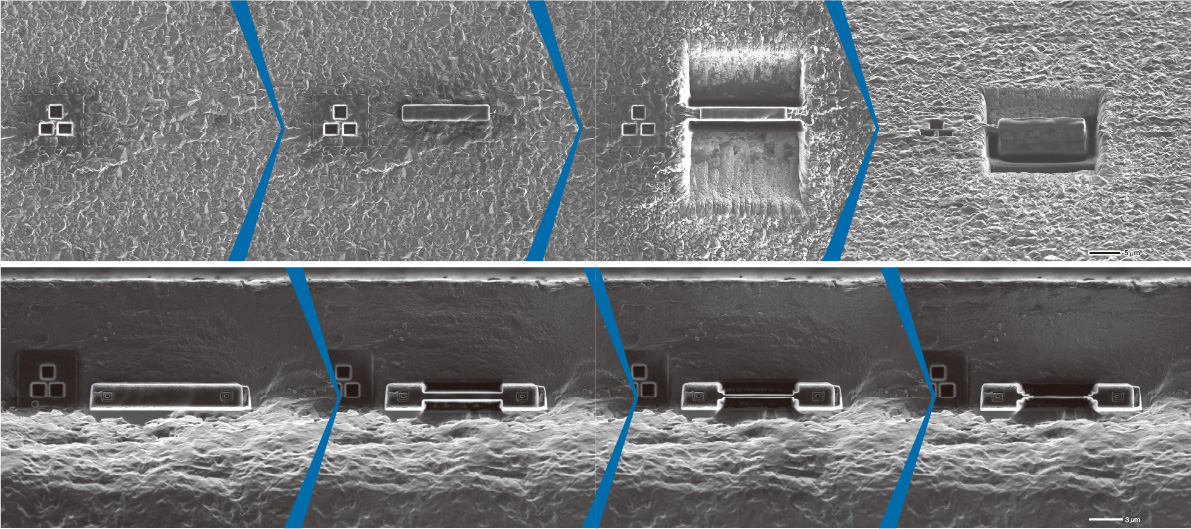
ตัวอย่าง: การชุบทองแดง
(บน) การเตรียมบล็อกชิ้นงานทดสอบโดยอัตโนมัติ (ล่าง) การทำให้บล็อกชิ้นงานบางลงโดยการประมวลผลอัตโนมัติ
เงื่อนไขการสังเกต: แรงดันไฟฟ้าเร่ง 30 kV, เครื่องตรวจจับ SED (ภาพซิม)
การถ่ายภาพ SEM ความละเอียดสูงและคอนทราสต์สูง
หยุดลังเล หยุดพลาดจุดสิ้นสุดในการกัด รูปภาพ SEM คุณภาพสูงช่วยคุณได้
ระบบตรวจจับสัญญาณ
มีเครื่องตรวจจับหลายตัว รวมทั้งมาตรฐาน SED, UED และ iBED การเลือกเครื่องตรวจจับที่เหมาะสมทำให้สามารถสังเกตภาพที่คมชัดของตัวอย่างต่างๆ ภายใต้เงื่อนไขการทดลองต่างๆ
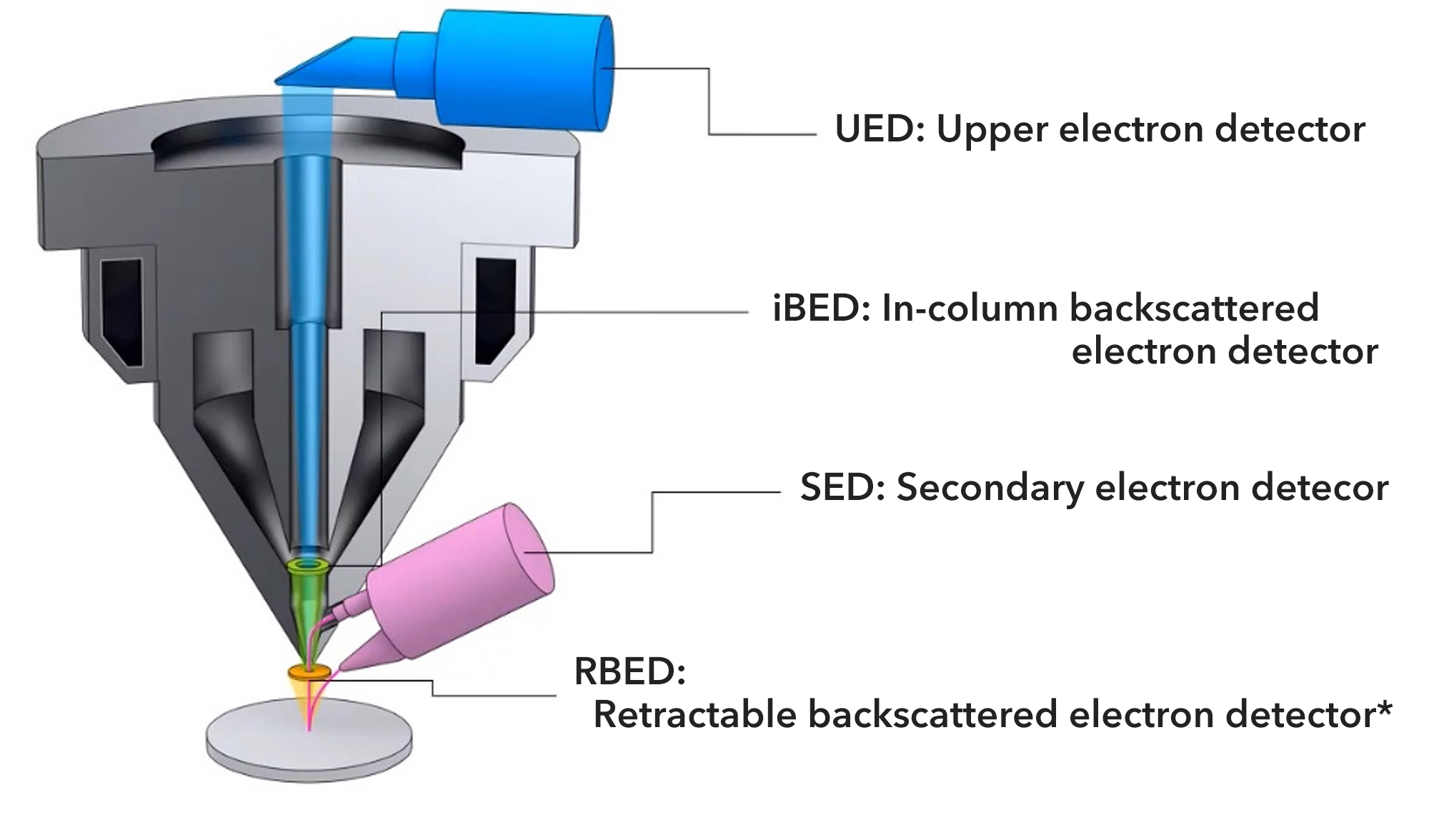
การถ่ายภาพ SEM ความละเอียดสูง
ระบบเลนส์ Super Conical ที่พัฒนาขึ้นใหม่ถูกสร้างขึ้นในคอลัมน์ SEM ซึ่งช่วยปรับปรุงประสิทธิภาพการถ่ายภาพอย่างมากที่แรงดันการเร่งความเร็วต่ำ การถ่ายภาพที่ยอดเยี่ยมนี้มีประโยชน์มากในการตรวจสอบสถานะการกัดปลายของชิ้นงานแบบลาเมลาโดยใช้ SEM
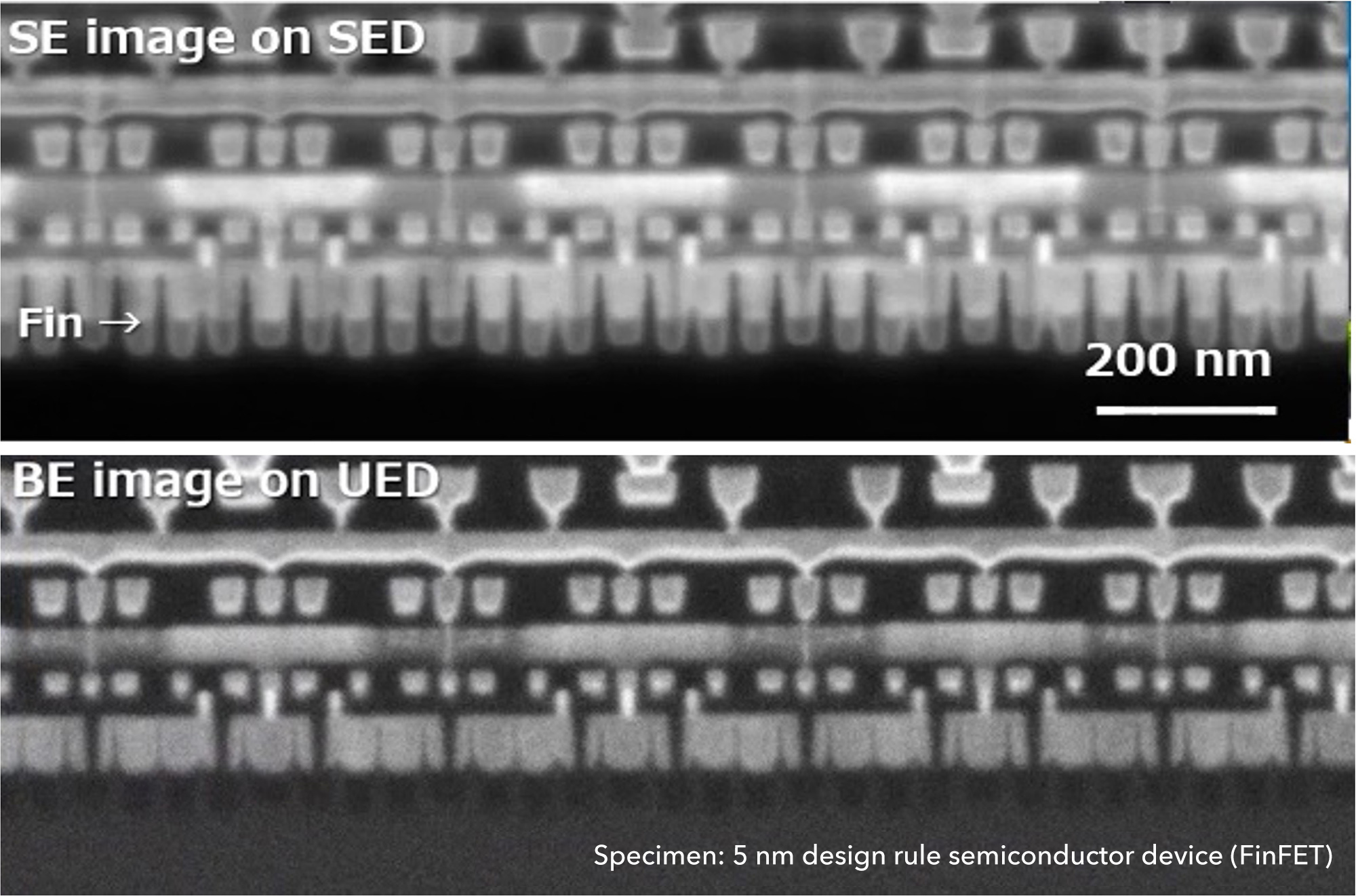
การถ่ายภาพ SEM ของส่วนตัดขวางที่เตรียมโดย FIB
เครื่องตรวจจับอิเล็กตรอนแบบกระจายแสงสะท้อนกลับ (RBED)* ที่มีขนาดเล็กมากและยืดหดได้สามารถใช้ได้แม้ในการเอียงเวทีสูง สำหรับการถ่ายภาพของภาคตัดขวางที่เตรียมโดย FIB ซึ่งต้องใช้ทั้งพื้นผิวของชิ้นงานทดสอบและการถ่ายภาพที่เอียง การรวมกันของเครื่องตรวจจับต่างๆ รวมถึง SED และ UED ทำให้เหมาะสำหรับการถ่ายภาพ SEM แบบภาคตัดขวาง

ตัวอย่าง: ภาพตัดขวางที่เตรียมโดย FIB ของอุปกรณ์หน่วยความจำแฟลช 3D NAND 200 นาโนเมตร
เงื่อนไขการสังเกต: แรงดันเร่ง 2 kV, ตัวตรวจจับ (บนสุด) ภาพอิเล็กตรอนแบบกระจายกลับ RBED, (ซ้าย) ภาพอิเล็กตรอนทุติยภูมิ SED,
(กลาง) ภาพอิเล็กตรอนแบบกระจายกลับ RBED, (ขวา) ภาพอิเล็กตรอนแบบกระจายกลับ UED
ซอฟต์แวร์บูรณาการ EDS*
ฟังก์ชันการวิเคราะห์ EDS ถูกสร้างขึ้นในซอฟต์แวร์ควบคุมเครื่องมือหลัก จึงช่วยให้สามารถวิเคราะห์องค์ประกอบของชิ้นงานได้โดยไม่ต้องเปลี่ยนซอฟต์แวร์ (ใช้ได้เฉพาะเมื่ออุปกรณ์ติดตั้ง JEOL EDS*)

กำลังสูงและการประมวลผล FIB คุณภาพสูง
เพื่อการเตรียมชิ้นงานทดสอบที่ดีที่สุด การประมวลผล FIB ที่ทรงพลังยิ่งขึ้น
พื้นที่ขนาดใหญ่ การประมวลผล FIB ที่รวดเร็ว
คอลัมน์ FIB ช่วยให้สามารถประมวลผลด้วยลำแสง Ga ไอออนที่มีกระแสสูง (สูงสุด 100 nA)
การประมวลผลกระแสสูงนี้มีประสิทธิภาพอย่างยิ่งสำหรับการถ่ายภาพและการวิเคราะห์พื้นที่ขนาดใหญ่
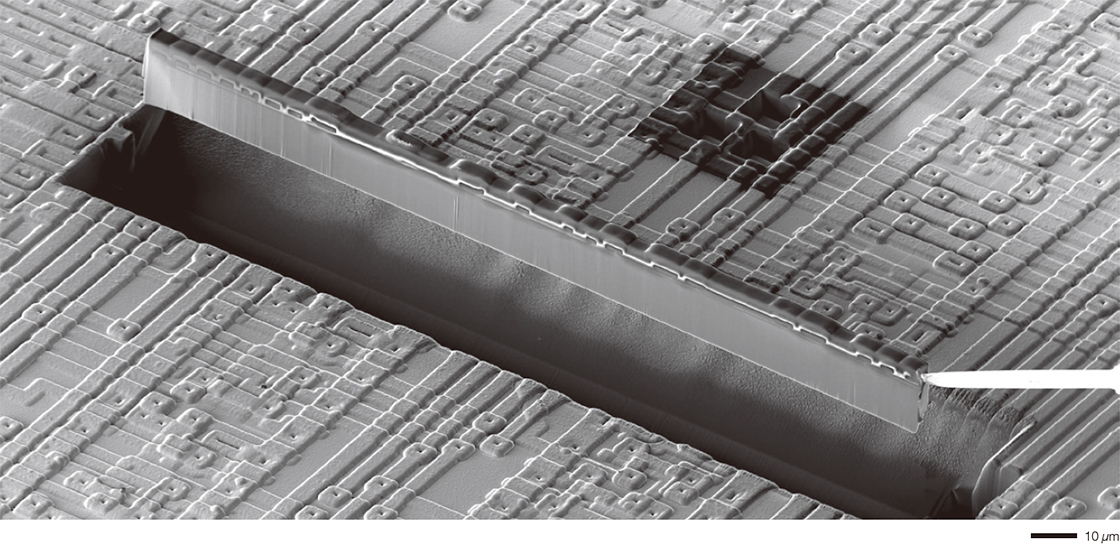
ตัวอย่าง: อุปกรณ์สารกึ่งตัวนำ
เงื่อนไขการสังเกต: แรงดันเร่ง 3 kV, ภาพอิเล็กตรอนทุติยภูมิของเครื่องตรวจจับ SED
บล็อกตัวอย่าง (200 × 4 × 15 μm) เก็บตัวอย่างชิ้นงานด้วย OmniProbe 400*
การกำจัดชั้นความเสียหายด้วยการประมวลผลแบบ kV ต่ำ
คอลัมน์ FIB ถูกตั้งค่าให้ระยะการทำงานสั้นกว่า JEOL รุ่นก่อนหน้า เมื่อใช้ร่วมกับพาวเวอร์ซัพพลายใหม่ ทำให้ประสิทธิภาพการประมวลผลดีขึ้นอย่างมากที่แรงดันไฟฟ้าที่มีอัตราเร่งต่ำ การเพิ่มระบบควบคุมใหม่ ทำให้ได้ความสามารถในการกัดละเอียดที่มีประสิทธิภาพสูงซึ่งจำเป็นสำหรับการเตรียมแผ่นลาเมลลาที่มีคุณภาพ
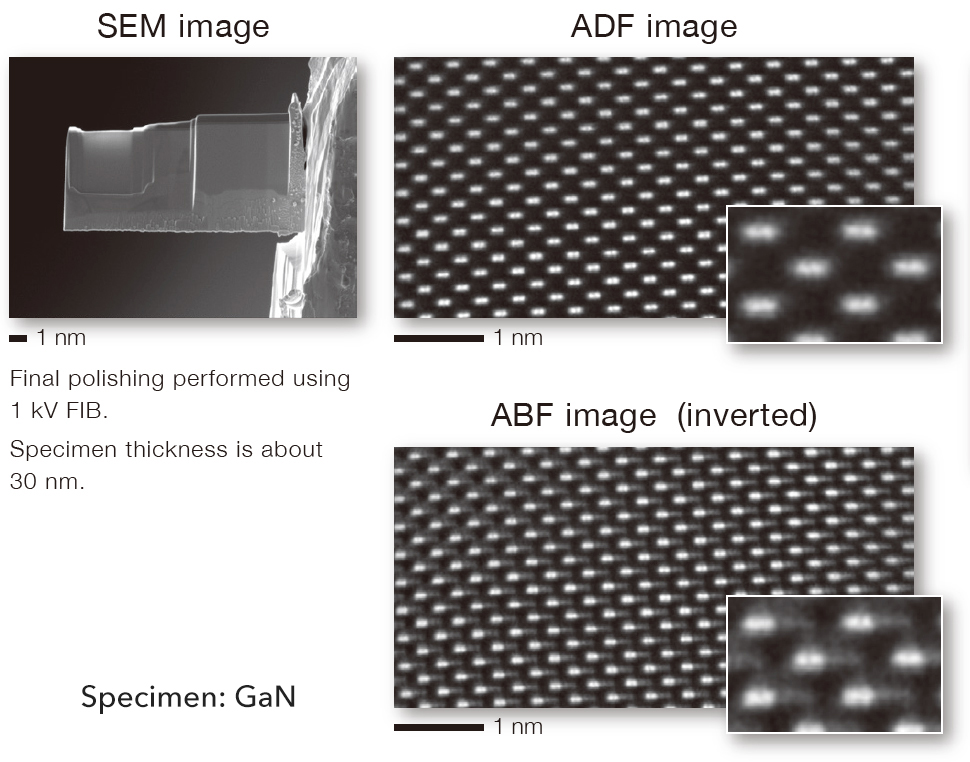
การออกแบบห้องและเวทีใหม่
ยืดหยุ่นสูง เอียงสูง & เวทีขนาดใหญ่เพื่อตอบสนองทุกความต้องการ
กำลังโหลดชิ้นงานขนาดใหญ่
JIB-PS500i ใช้ห้องเก็บตัวอย่างขนาดใหญ่และสเตจมอเตอร์ขนาดใหญ่แบบ 5 แกนเต็มรูปแบบที่พัฒนาขึ้นใหม่ เพิ่มระยะการเคลื่อนที่ของสเตจในขณะที่รองรับชิ้นงานขนาดใหญ่ ระยะขนาดใหญ่นี้ช่วยให้สามารถประมวลผลและถ่ายภาพพื้นผิวทั้งหมดของชิ้นงานที่มีเส้นผ่านศูนย์กลาง 130 มม. นอกจากนี้ ยังสามารถโหลดตัวอย่างที่มีความสูงไม่เกิน 80 มม. ไปยังห้องเก็บตัวอย่างได้

บรรจุเวเฟอร์ซิลิคอนขนาดเส้นผ่านศูนย์กลาง 150 มม. เข้าไปในห้องเก็บตัวอย่าง

AVRT Engine เพื่อกำหนดขีดจำกัดการเคลื่อนไหวโดยใช้โมเดล 3 มิติ
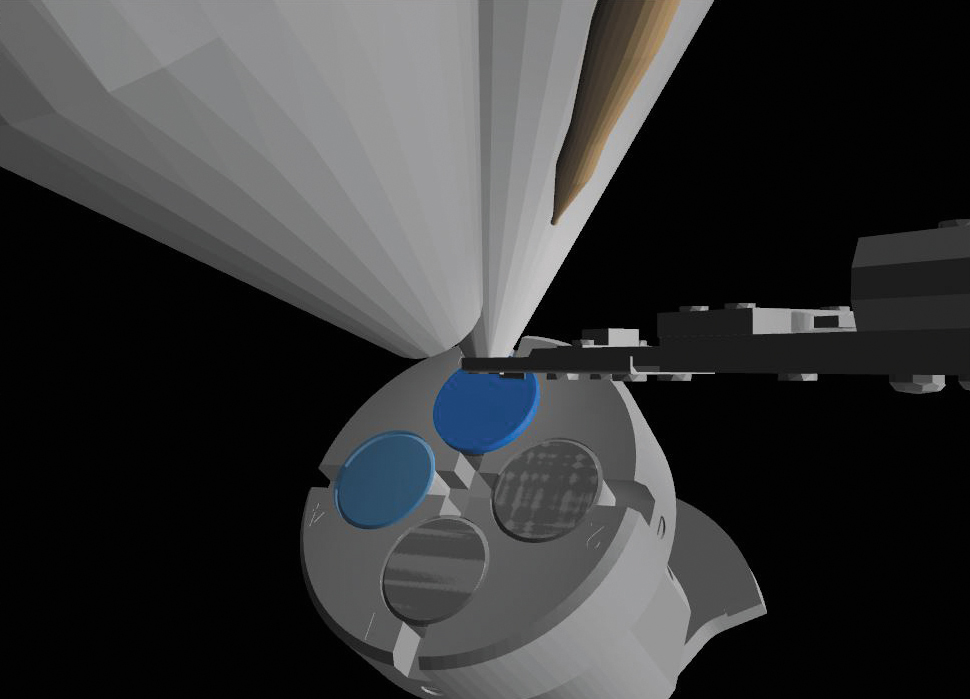
AVERT Engine ใช้เพื่อระบุขีดจำกัดการเคลื่อนที่ของชิ้นงานทดสอบโดยใช้แบบจำลอง 3 มิติของแท่นวางชิ้นงาน แท่นวาง และวัตถุภายในห้องเพาะเลี้ยง ดังนั้นไม่ว่าในสภาวะใด ชิ้นงานจะไม่สามารถรบกวนเครื่องตรวจจับและเลนส์ใกล้วัตถุได้
* เป็นตัวเลือก
ข้อบ่งชี้จำเพาะ
SEM
| ความละเอียดของภาพ | 0.7 นาโนเมตร (15 กิโลโวลต์) 1.4 นาโนเมตร (1 กิโลโวลต์) 1.0 นาโนเมตร (1 kV, โหมด BD) |
|---|---|
| การอวดอ้าง | ×50 ถึง ×1,000,000 (โหมด STD) ×1,000 ถึง ×1,000,000 (โหมด UHR) ×10 ถึง ×19,000 (โหมด LDF) (ขนาดการพิมพ์ 128 มม. × 96 มม.) |
| แรงดันไฟฟ้าลงจอด | 0.01 ถึง 30 kV |
| ลำแสงปัจจุบัน | ~1 pA ถึง 500 nA หรือมากกว่า |
| แรงดันไบอัสของชิ้นงานทดสอบ | 0.0 ถึง -5.0 กิโลโวลต์ |
| ปืนอิเล็กตรอน | ปืนอิเล็กตรอนแบบปล่อยสนามไฟฟ้า Schottky Plus ในเลนส์ |
| มุมรูรับแสง เลนส์ควบคุม (ACL) |
Built-in |
| เลนส์ใกล้วัตถุ | เลนส์ป้องกันภาพสั่นไหว |
| ความลึกที่ยาวนานของ โหมดโฟกัส (LDF) |
Built-in |
| เครื่องตรวจจับ (มาตรฐาน) | เครื่องตรวจจับอิเล็กตรอนทุติยภูมิ (SED) ตัวตรวจจับอิเล็กตรอนส่วนบน (UED) ตัวตรวจจับอิเล็กตรอนแบบกระจายกลับในเลนส์ (iBED) |
IBF
| ความละเอียดของภาพ | 3 นาโนเมตร (ที่ 30 กิโลโวลต์) |
|---|---|
| การอวดอ้าง | ×50 ถึง ×300,000 (จำกัดขึ้นอยู่กับแรงเร่ง) |
| แรงดันไฟฟ้าเร่ง | 0.5 ถึง 30 kV |
| ลำแสงปัจจุบัน | 1.0 pA ถึง 100 nA สลับได้ 13 สเตจ (30 kV) |
| รูรับแสงที่เคลื่อนย้ายได้ | มอเตอร์ขับเคลื่อน 16 สเตจสลับได้ (3 ขั้นตอนเป็นตัวช่วย) |
| แหล่งกำเนิดไอออน | แหล่งกำเนิดไอออนโลหะเหลวของ Ga |
| รูปทรงการประมวลผล โดยการกัด |
สี่เหลี่ยมผืนผ้า วงกลม รูปหลายเหลี่ยม จุด เส้น BMP |
ขั้นตอนตัวอย่าง
| ชนิดภาพเขียน | ระยะโกนิโอมิเตอร์แบบยูเซนตริกแบบเต็ม |
|---|---|
| Control | การควบคุมด้วยคอมพิวเตอร์, การควบคุมมอเตอร์ 5 แกน การวัดสัญญาณรบกวน 3 มิติ AVRT Engine |
| ตัวอย่าง การเคลื่อนไหว |
X: 130 มม. |
| Y: 130 มม. | |
| Z: 1.0 มม. ถึง 40 mm | |
| ความเอียง: –40.0 ถึง 93.0° | |
| การหมุน: 360.0° ไม่มีที่สิ้นสุด |
ดาวน์โหลดแคตตาล็อก
รูปภาพ

ข้อมูลเพิ่มเติม
คุณเป็นผู้เชี่ยวชาญทางการแพทย์หรือบุคลากรที่เกี่ยวข้องกับการรักษาพยาบาลหรือไม่?
ไม่
โปรดทราบว่าหน้าเหล่านี้ไม่ได้มีวัตถุประสงค์เพื่อให้ข้อมูลเกี่ยวกับผลิตภัณฑ์แก่ประชาชนทั่วไป