
คุณสมบัติ
ทำให้สามารถสังเกตและวิเคราะห์ได้อย่างราบรื่น
เพิ่มขีดความสามารถในการประมวลผล FIB ให้แข็งแกร่งยิ่งขึ้น การถ่ายภาพ SEM ที่ได้รับการปรับปรุงอย่างมากโดยคอลัมน์ออปติคอลใหม่ ปรับปรุงความสามารถในการทำงานด้วยความสามารถในการเชื่อมโยง
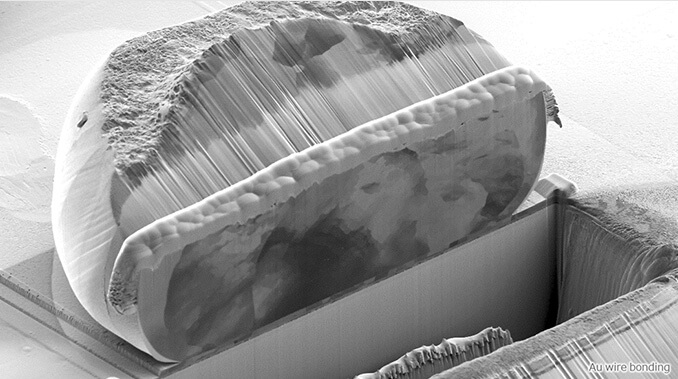
FIB : เพิ่มความสามารถในการประมวลผล
- ・ระบบควบคุมขั้นสูง
ระบบสแกนเวกเตอร์ช่วยให้สามารถประมวลผลรูปร่างตามอำเภอใจได้อย่างราบรื่น
เปิดใช้งานการสังเกตและวิเคราะห์ 3D อย่างง่าย - ・ลำแสงไอออนขนาดใหญ่ที่มีกระแสสูงถึง 90 nA
เปิดใช้งานการประมวลผลชิ้นงานทดสอบด้วยความเร็วสูง
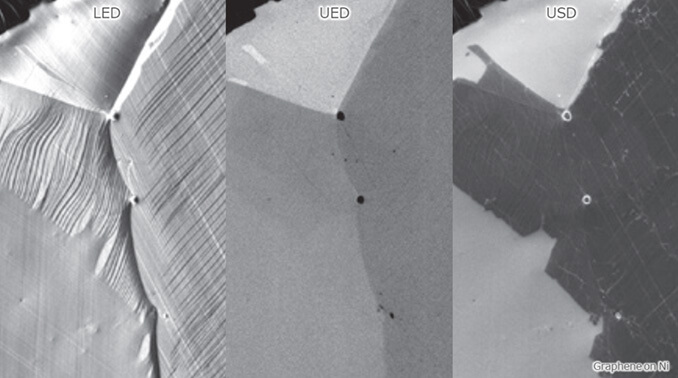
SEM : ปรับปรุงประสิทธิภาพการถ่ายภาพ
- ・ความละเอียดสูงที่แรงดันความเร่งต่ำ
การผสมผสานระหว่างเลนส์ใกล้วัตถุทรงกรวยแบบไฮบริดและ GENTLEBEAM™ ทำให้เกิดความละเอียดสูงที่แรงดันการเร่งความเร็วต่ำ (1.6 นาโนเมตรที่ 1 kV) - ・การได้มาซึ่งภาพที่หลากหลาย
ตัวตรวจจับ UED และ USD ที่เพิ่มเข้ามาใหม่ช่วยให้สามารถรับอิมเมจ SEM ที่หลากหลายซึ่งมีข้อมูลเกี่ยวกับคุณสมบัติ องค์ประกอบทางเคมี และโครงสร้างผลึก - ・ความละเอียดสูงที่กระแสโพรบขนาดใหญ่
การรวมกันของ "ปืนอิเล็กตรอน Schottky ในเลนส์" และเลนส์ควบคุมมุมรับแสง (ACL) รักษาความละเอียดสูงที่กระแสโพรบขนาดใหญ่ ทำให้สามารถวิเคราะห์ g ได้อย่างรวดเร็ว
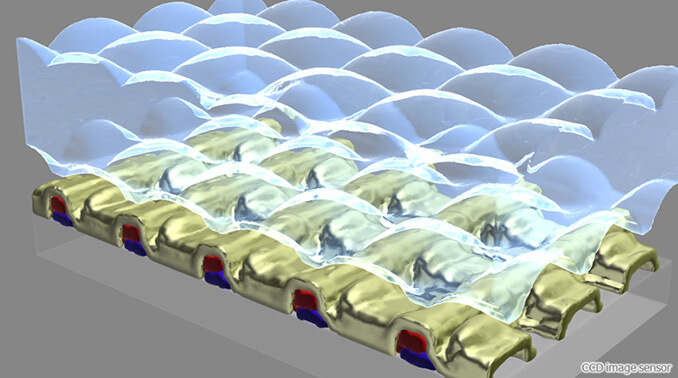
การสังเกตและการวิเคราะห์ 3 มิติ
- ・การวัดอัตโนมัติที่เสถียร
ระบบ Slice and View (ส่วนประกอบมาตรฐานของ JIB-4700F) ช่วยให้สามารถประมวลผล สังเกต และวิเคราะห์ซ้ำได้โดยอัตโนมัติ - ・สร้างใหม่ได้ง่าย
หลังจากทำตามขั้นตอนซ้ำๆ ซอฟต์แวร์สร้างภาพ 3 มิติ (IB-3STKV)* จะได้รับภาพที่สร้างใหม่ 67020 มิติจากข้อมูลที่ได้มาแบบอนุกรม
ใบสมัคร
โซลูชันอเนกประสงค์ที่นำเสนอโดย FIB-SEM
การเตรียมชิ้นงานตัดขวาง, การเตรียมชิ้นงานทดสอบ TEM, การสังเกต 3 มิติ, การวิเคราะห์ 3D EDS, การวิเคราะห์ 3D EDSD, การประมวลผลรูปร่างละเอียด
ข้ามส่วน
ระบบมัลติบีม JIB-4700F ช่วยให้ทำงานได้อย่างราบรื่นตั้งแต่การเตรียมฟิล์มป้องกัน การกัดชิ้นงาน ไปจนถึงการสังเกตและวิเคราะห์ภาพตัดขวาง คอลัมน์ FIB ช่วยให้สามารถประมวลผลด้วยลำแสง Ga ไอออนขนาดใหญ่ในปัจจุบัน (สูงสุด 90 nA) การประมวลผลกระแสขนาดใหญ่นี้มีประสิทธิภาพอย่างยิ่งสำหรับการเตรียมชิ้นงานขนาดใหญ่
ตัวอย่าง TEM
การผสมผสานระหว่าง JIB-4700F และระบบควบคุมช่วยให้การเตรียมชิ้นงานทดสอบ TEM เป็นไปอย่างราบรื่น การใช้เครื่องตรวจจับอิเล็กตรอนแบบกระจายกลับทำให้คุณสามารถสังเกตความคืบหน้าของการกัด FIB ด้วยภาพ SEM ความละเอียดสูง JIB-4700F ช่วยเพิ่มประสิทธิภาพการทำงาน เช่น การตรวจจับจุดสิ้นสุดของการกัดขั้นสุดท้ายสำหรับการเตรียมชิ้นงานทดสอบ TEM
การวิเคราะห์ 3D-EDS
3D-EDS* เปิดใช้งานขั้นตอนอนุกรมอัตโนมัติของการกัด FIB ทั้งสองด้วยลำแสงไอออนตกกระทบที่พื้นผิวชิ้นงานทดสอบตามปกติ และการวิเคราะห์ EDS โดยใช้โพรบ SEM ความละเอียดสูงที่กระแสโพรบขนาดใหญ่ช่วยให้วิเคราะห์ EDS ได้อย่างรวดเร็ว
การวิเคราะห์ 3D-EBSD
เครื่องตรวจจับ EBSD* ซึ่งวางอย่างเหมาะสม ช่วยให้สามารถประมวลผลและวิเคราะห์ได้โดยไม่ต้องมีการเคลื่อนไหวบนเวที คุณสมบัตินี้ให้ความแม่นยำในตำแหน่งสูงในการรับข้อมูลด้วยเวลาที่สั้นลง